Clear Sky Science · zh
用于GaN基结构侧壁损伤修复的原子层刻蚀分子动力学模拟
为未来显示器打造更锐利、更明亮的芯片
现代设备——从虚拟现实头戴装置到超高分辨率显示屏——依赖于由氮化镓(GaN)制成的越来越小的光源。随着工程师不断缩小这些器件,制造过程中切割出的微小侧壁会严重受损,把能量以热的形式浪费掉而不是发光。本文研究了一种有前景的“纳米抛光”方法——原子层刻蚀(ALE),它可以逐原子修复这些损伤,为更明亮、更高效的微型LED和功率电子器件铺平道路。
为何侧壁损伤很重要
GaN器件由超薄层堆栈构成,其中包含实际发光的InGaN/GaN多量子阱。为分隔数以百万计的微小像素,制造商通常使用基于氯的等离子体进行严酷的干法刻蚀。该工艺快速且精确,但它会用高能离子轰击暴露的侧壁,断裂化学键、混合原子,留下薄而无序的“死亡”层。传统的清理方法——在KOH或TMAH等化学品中进行温和的湿法蚀刻——只能去除部分损伤,而且无法深入狭窄的垂直侧壁。随着器件继续微缩,这些疤痕已成为影响性能和大规模生产的主要障碍。
逐层剥离的原子级手术刀
原子层刻蚀(ALE)试图通过用一个精心编排的两步循环取代等离子体刻蚀的混乱轰击来解决这个问题。首先,化学步骤仅在最外层原子层上形成氯化层。接着,低能量的氩离子束将该被改性的层敲掉,就像削下一片薄木板。重复这个循环可以以近原子精度剥离受损材料,同时避免产生新的损伤。作者使用分子动力学模拟——一种追踪单个原子随时间演化的虚拟显微镜——来测试ALE在清理GaN基侧壁方面的效果,以及哪种离子入射角在深度修复和表面光滑度之间最合适。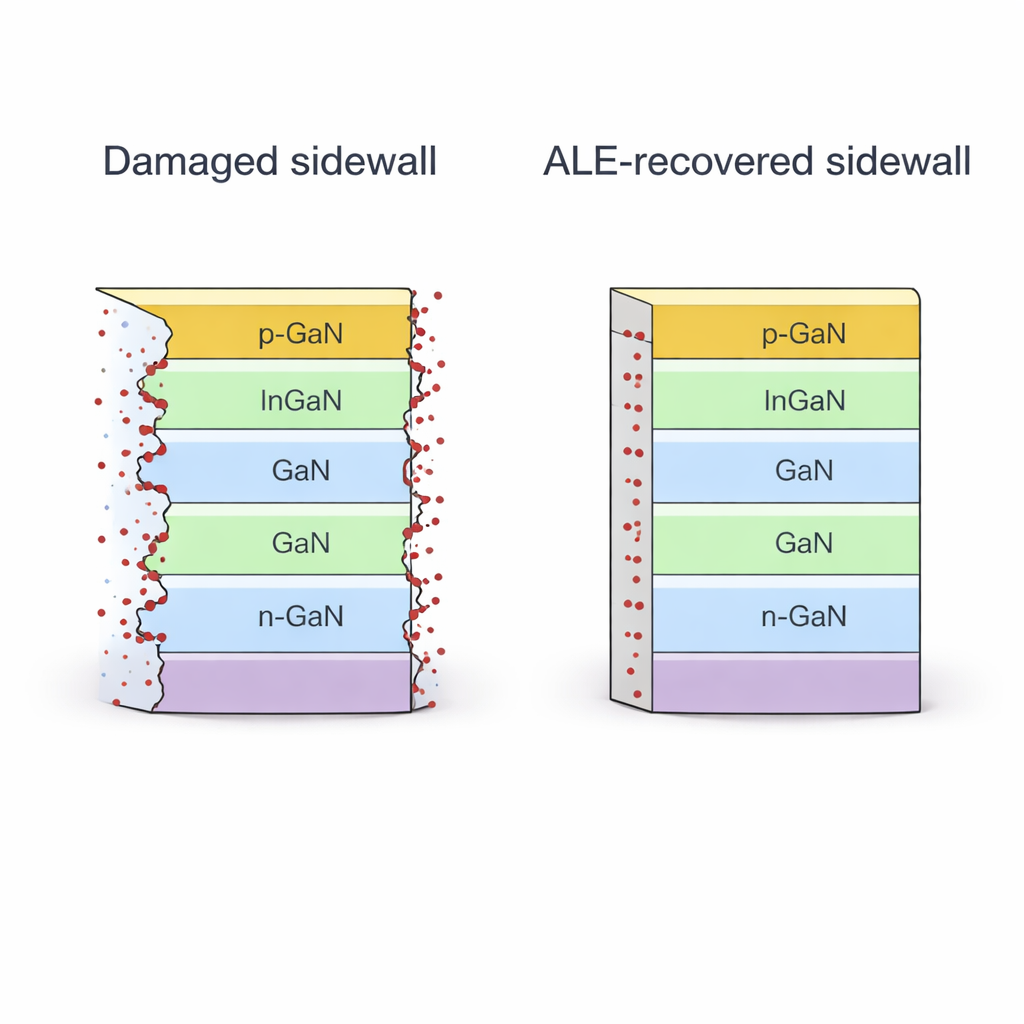
逐原子模拟损伤与修复
在模拟中,研究团队首先构建了理想、无缺陷的GaN、InGaN以及现实的多量子阱堆栈模型。然后他们用模拟的离子轰击(类似真实等离子体刻蚀)对侧壁进行“预损伤”,形成高、中、低三种初始损伤情形。随后,他们施加了重复的ALE循环,改变氩离子撞击侧壁的入射角——从表面测量为60°、70°或80°。模拟跟踪了保持无序状态的原子数量、损伤层的深度以及随着循环进行表面粗糙度的变化。
层状堆栈内部发生了什么
原子尺度的“影片”揭示了若干关键行为。氯化步骤可靠地形成了一层薄而自限制的覆盖层,而在随后的离子步骤中大部分被移除,证实了ALE的基本机制。有趣的是,当浅入射角的离子沿侧壁掠过时,来自InGaN量子阱的一些铟原子会横向迁移到相邻的GaN层中。这种微妙的重排使层间表面组成更均匀,帮助整个堆栈以更均衡的方式被蚀刻。在三种不同的初始损伤水平中,ALE都去除了表面和亚表面的无序区域,将受损原子数减少了约47%以上,并把剩余的缺陷深度驱动到相似且较小的数值。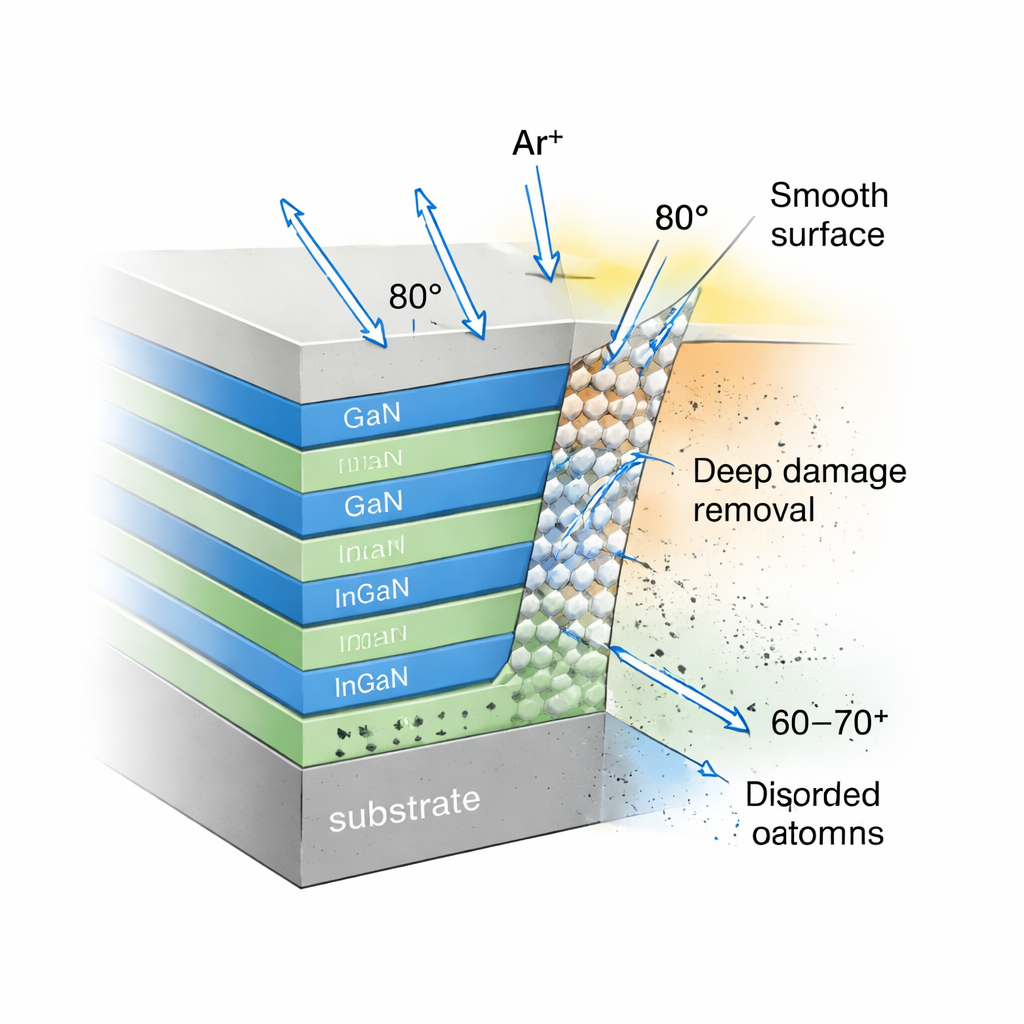
寻找离子束的最佳角度
离子束的入射角被证明至关重要。在较低角度(约60°–70°)时,离子侵入更深,更快剥离被严重损坏的材料,但会留下稍微粗糙的表面。在更陡的80°角时,去除速度较慢且浅,但所得侧壁明显更光滑。这种权衡促使作者提出一个实用的两步配方:先以60°–70°的入射角清除深层损伤,然后切换到约80°进行最终的“抛光”以平整表面而不致过度刻蚀。他们的模拟表明,这种双角度方法在不同初始损伤程度下都有效。
对未来器件的意义
对非专业读者来说,核心结论是:该研究表明原则上可以逐原子抹去制造过程留下的大部分不可见疤痕。通过在原子层刻蚀设备中调节离子束的角度和能量,制造商可能恢复GaN基侧壁的晶体完好性,提高光输出和能源效率,同时不牺牲下一代显示器和功率芯片所需的小尺寸。该工作也展示了计算机模拟如何作为原子尺度的设计实验室,在实际刻蚀任何晶圆之前为工艺选择提供指导。
引用: Kim, E.K., Hong, J.W., Lim, W.S. et al. Molecular dynamics simulation of atomic layer etching for sidewall damage recovery in GaN-based structures. Sci Rep 16, 7110 (2026). https://doi.org/10.1038/s41598-026-38333-w
关键词: 原子层刻蚀, GaN微型LED, 侧壁损伤, 分子动力学模拟, InGaN量子阱