Clear Sky Science · zh
类同轴TGV的高频特性分析与优化
更好微小“导线”为未来电子学为何重要
随着我们的手机、基站和人工智能加速器向更高的无线电频率推进,薄弱环节往往不是芯片本身,而是那些在堆叠芯片之间传输信号的微小“连线”。本文研究了一种特殊的垂直连线,称为类同轴穿玻璃通孔(TGV),并展示了如何通过精心设计与计算机辅助优化使这些链路减少信号损失,从而为更快、更可靠的 5G、雷达和未来 6G 系统铺平道路。
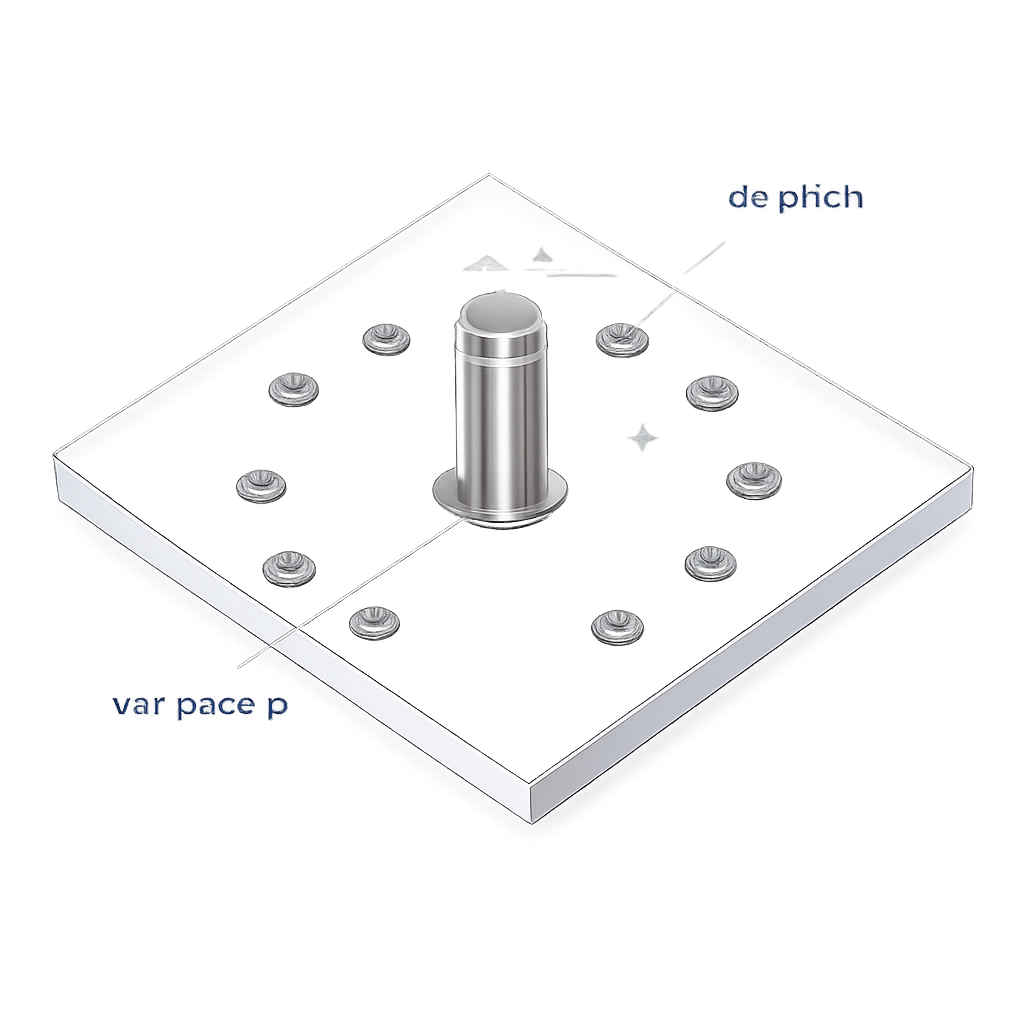
从平面芯片到三维堆栈
几十年来,芯片性能通过缩小晶体管尺寸遵循摩尔定律。但如今这种方法正面临物理和经济上的极限,工程师们转向三维封装:将芯片堆叠并进行垂直互连。传统的垂直互连是钻穿硅的通孔(TSV),但硅在高频下相对“损耗”较大,且与周围材料的热膨胀系数不同,这种不匹配会随着时间导致连接开裂。玻璃作为基底更具吸引力:它具有更低的电损耗且热膨胀与硅接近,这意味着信号在传输过程中以更少的能量转化为热损耗传播更远,并且结构能更好地承受快速温度变化。
为何类同轴通孔优于简单孔洞
基本的穿玻璃通孔只是穿过玻璃的单根金属柱。在日常频率下这通常没问题,但在用于先进通信的毫米波和太赫兹频段,它会出现问题。阻抗不匹配导致反射,电磁场泄漏到附近电路,且密集排列的通孔会相互干扰。类同轴设计通过用一圈接地通孔环绕中央信号通孔来解决这些问题。这种排列模仿了同轴电缆:接地体形成屏蔽以束缚场,降低干扰,并使线的电学“尺寸”更易于控制。
用模型与仿真深入剖视
作者首先建立了类同轴通孔的详细电磁模型,使用成熟的物理方法将其行为分解为等效电阻、互感、电容和漏散路径。这些量取决于三个主要几何参数:接地通孔与信号通孔的间距(节距)、信号通孔的半径以及接地通孔的数量。然后他们用高达 100 GHz 的三维全波仿真验证了这一解析描述,跟踪两个关键指标:有多少信号被反射回去(S11)以及有多少通过(S21)。S21 越高意味着插入损耗越小,从而传输越好。

教计算机调节几何参数
团队没有手工尝试数十或数百种几何体,而是采用两步优化策略。首先,他们应用一种称为响应面法的统计方法。通过精心选择仅 17 个覆盖节距、半径和通孔数量合理范围的仿真设计,他们拟合出一个平滑的数学表面,用于从任意三参数组合预测 S21。这个替代模型通过统计检验并被证明与仿真高度一致。其次,他们将这个快速模型输入遗传算法——一种受进化启发的搜索方法。该算法“繁殖”大量候选设计,保留表现最好的,并逐步找到在 100 GHz 时使 S21 最大的参数组合。
优化设计带来的效果
算法找到的最佳设计采用稍微紧凑一些的接地通孔环、略粗一些的中央通孔,以及总共十个接地通孔。简单来说,这种组合减少了磁能储存,降低了金属表面的电阻,并增强了信号路径周围的屏蔽。最终结果是在 100 GHz 时插入损耗改善了 0.0052 分贝——对于这个本已低损的结构,相对提升约 22%。虽然这个数值听起来很小,但高频系统通常包含许多此类垂直互连;在每个环节上都削减一点损耗,累计起来会带来更好的信噪比、更远的通信距离以及更少以热量形式的能量浪费。
对未来高速系统的意义
对非专业读者来说,结论是:一旦信号达到几十到数百吉赫兹,微小连接几何的细微调整就可能产生显著影响。这项工作既提供了基于物理的设计配方,也给出了一个实用的优化方法,用于设计低损耗的穿玻璃通孔。通过表明统计建模与进化搜索的混合方法胜过更传统的优化手段,研究为其他高频元件提供了可复用的方法。随着电子技术继续向三维和更高频段发展,这类优化过的类同轴玻璃通孔将有助于保持信号清晰、控制功耗并提升复杂系统的可靠性。
引用: Chen, S., Wang, J., Liu, X. et al. High-frequency characteristics analysis and optimization of coaxial-like TGVs. Sci Rep 16, 4796 (2026). https://doi.org/10.1038/s41598-026-35007-5
关键词: 穿玻璃通孔, 3D 封装, 毫米波, 射频互连, 遗传算法优化