Clear Sky Science · zh
用于高纵横比与复合微沟槽三维形貌的傅里叶ptychographic相干扫描干涉法
窥视微小深沟
现代微芯片和传感器充满了超窄且超深的沟槽——这些微米级沟槽深度可达300微米,但宽度仅约10微米。它们的精确三维形状会显著影响压力传感器、先进发光二极管和超材料光学器件等器件的性能。迄今为止,要清晰观察这些隐藏结构通常要么需要破坏样品,要么接受模糊、不完整的测量结果。本文提出了一种新的光学方法,它透过材料而不是仅从表面反射光,从而在不切开样品的情况下描绘出这些深部特征的清晰三维图谱。
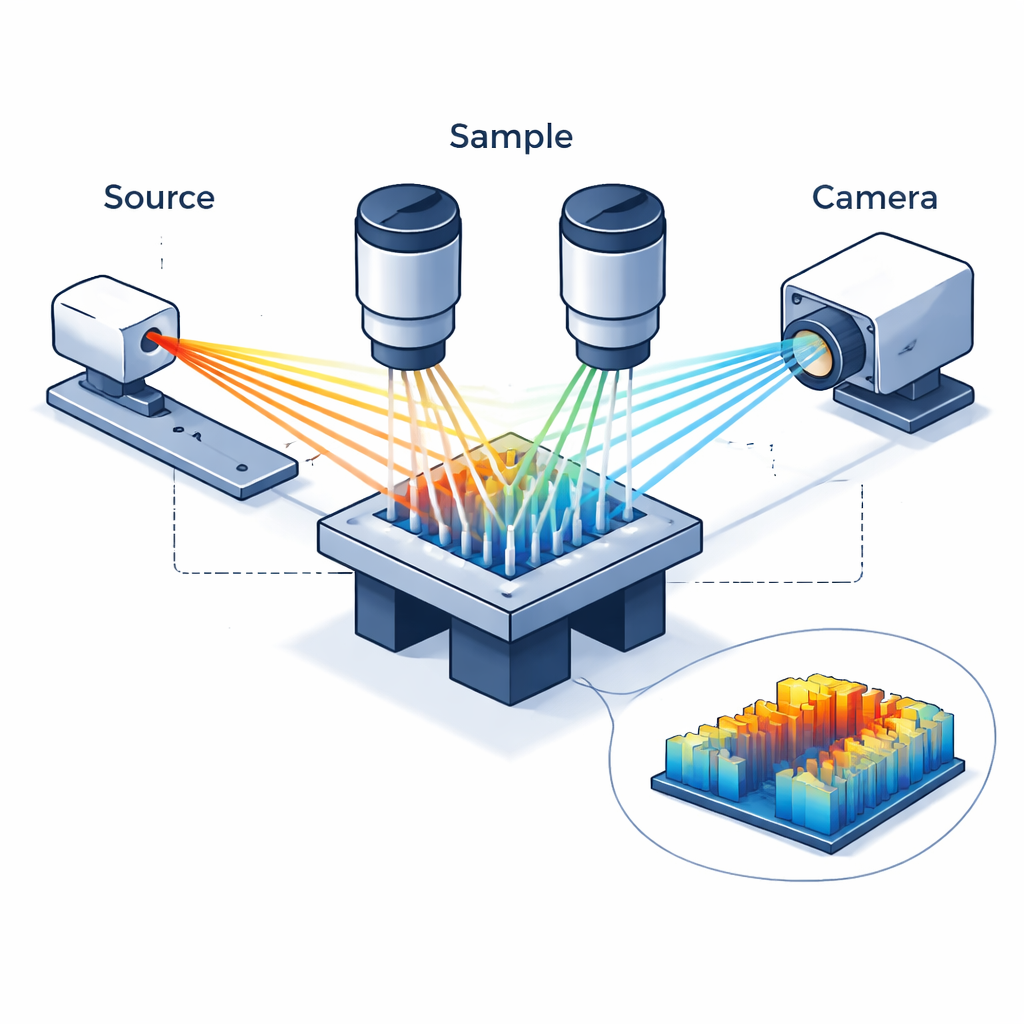
为何深沟至关重要
这些高纵横比沟槽——深度远大于宽度——是微型化技术的关键构件。在微机电系统(MEMS)中,它们构成柔性弹簧和梳状结构,用于测量压力或位移。在先进LED和光学元件中,它们可以引导光线并提高效率。然而,它们的性能对底部光滑度、侧壁垂直性以及深度与宽度是否在亚微米级别符合设计等细节非常敏感。工业上通常依赖电子显微镜进行检查,但这类方法需要切割或以其他方式损伤样品,不适合常规在线检测。
现有光学工具的局限
无损光学方法试图用光代替切割,但在面对这些极端几何结构时一直受限。一种主流技术——相干扫描干涉仪(coherence scanning interferometry)用宽带光照射表面并分析干涉条纹以构建高度图。对于浅而开阔的结构,该方法效果良好。但在又深又窄的沟槽中,光在陡峭的侧壁之间发生多次反射和散射,导致条纹被冲淡、信号嘈杂,尤其是在沟槽底部——工程师最需要可靠测量的位置。采用更弱且低角度的照明可以改善信号清晰度,但会模糊细节,从而在分辨率与可靠性之间产生权衡。
不是只看表面,而是透视内部
作者提出的方法称为傅里叶ptychographic相干扫描干涉法(FP-CSI),它改变了测量几何。系统不再通过样品反射光,而是在精心平衡的干涉仪中将近红外光透过透明硅晶圆。一个微小的照明点进行横向位移,使样品受到许多略有不同角度的近乎平行光照射。由于光线仅通过结构一次且发散很小,信号受扭曲显著减少,即使在极深沟槽底部干涉条纹仍然强烈。随后该方法修正记录信号中的微小畸变,并在频域中合成多角度视图,有效拼接出更大的光学孔径,恢复精细细节而无需昂贵的迭代计算。
真实器件的清晰三维图谱
利用FP-CSI,团队测量了单一硅沟槽(深度300微米、宽度小至10微米)以及包含多层沟槽的复杂多层MEMS压力传感器。在所有案例中,该方法生成的三维细节图与电子显微镜的交叉验证结果高度一致,但无需损毁样品。宽度和深度误差在重复试验中约为百分之一或更小。系统能够分辨仅相距1.3微米的线性特征——基本上达到了光学所限的分辨率,并且关键是,在纵横比大于10:1的模型沟槽底部仍能保持几乎相同的清晰度,而传统反射式干涉仪在这些情况下大多失效。

对未来制造的意义
对非专业读者而言,核心信息是FP-CSI提供了一种快速且无需切割即可“看到”透明微器件内极深极窄沟槽精确三维形状的方法。通过将两种此前分离的成像思想——基于干涉的高度测量与多角度合成成像——的优势结合起来,该技术克服了长期存在的清晰度与可靠性之间的折衷。这使其成为下一代半导体制造、MEMS生产及其他微光电系统中一项有前景的检测工具,在这些领域中看不见的微小形状常决定器件是否合格。
引用: Li, Y., Yuan, Q., Huo, X. et al. Fourier ptychographic coherence scanning interferometry for 3D morphology of high aspect ratio and composite micro-trenches. Light Sci Appl 15, 93 (2026). https://doi.org/10.1038/s41377-026-02189-6
关键词: 三维光学计量, 微沟槽, MEMS检测, 干涉测量, 半导体制造