Clear Sky Science · tr
2B MoS2 transistörleri için sub-5 Å eşdeğer oksit kalınlığına sahip wafer ölçeğinde yüksek-κ HfO2 dielektrik filmler
Neden Daha İnce Yalıtkanlar Geleceğin Çipleri İçin Önemli?
Akıllı telefonlar, veri merkezleri ve yapay zeka, transistör adı verilen küçük elektronik anahtarlara dayanır. Bu anahtarları çiplere daha fazla sığdırırken enerji tüketimini azaltmak için mühendisler yalnızca transistörleri küçültmekle kalmamalı, davranışlarını kontrol eden yalıtkan katmanları da inceltmelidir. Bu makale, elektrik kaçak akımını hâlâ engelleyen son derece ince, yüksek kalitede bir yalıtkan film üretme ve bunu gelişmiş iki boyutlu (2B) transistör devrelerinde tam boyutlu waferler üzerinde kullanma yöntemini anlatıyor.
Yeni Bir Tür Ultra-Ince Elektrik Bariyeri
Her modern transistörün merkezinde akımı kanal boyunca açıp kapatan bir “kapı” bulunur. Bunların arasında ince bir yalıtkan katman, yani dielektrik yer alır. Yıllardır endüstri, fiziksel olarak kalın bir katmana ihtiyaç duymadan kanal üzerinde güçlü kontrol sağlayan yüksek-κ özellikli bir malzeme olan hafniyum oksidi (HfO2) kullanıyor. Ancak bu yaklaşımı birkaç atom kalınlığına indirgemek zordur: filmler genellikle çok fazla akıta izin verir veya elektriksel gerilim altında bozulur. Yazarlar, çok aşamalı oksidasyon atomik katman biriktirme (MOALD) adını verdikleri geliştirilmiş bir büyüme yöntemi sunuyor; bu yöntem, sadece 1,3 nanometre kalınlığında—yalnızca birkaç atom—HfO2 filmler üretiyor ve bunları yoğun ve kusur bakımından yeterince düşük tutarak güvenilir çalışmayı sağlıyor. 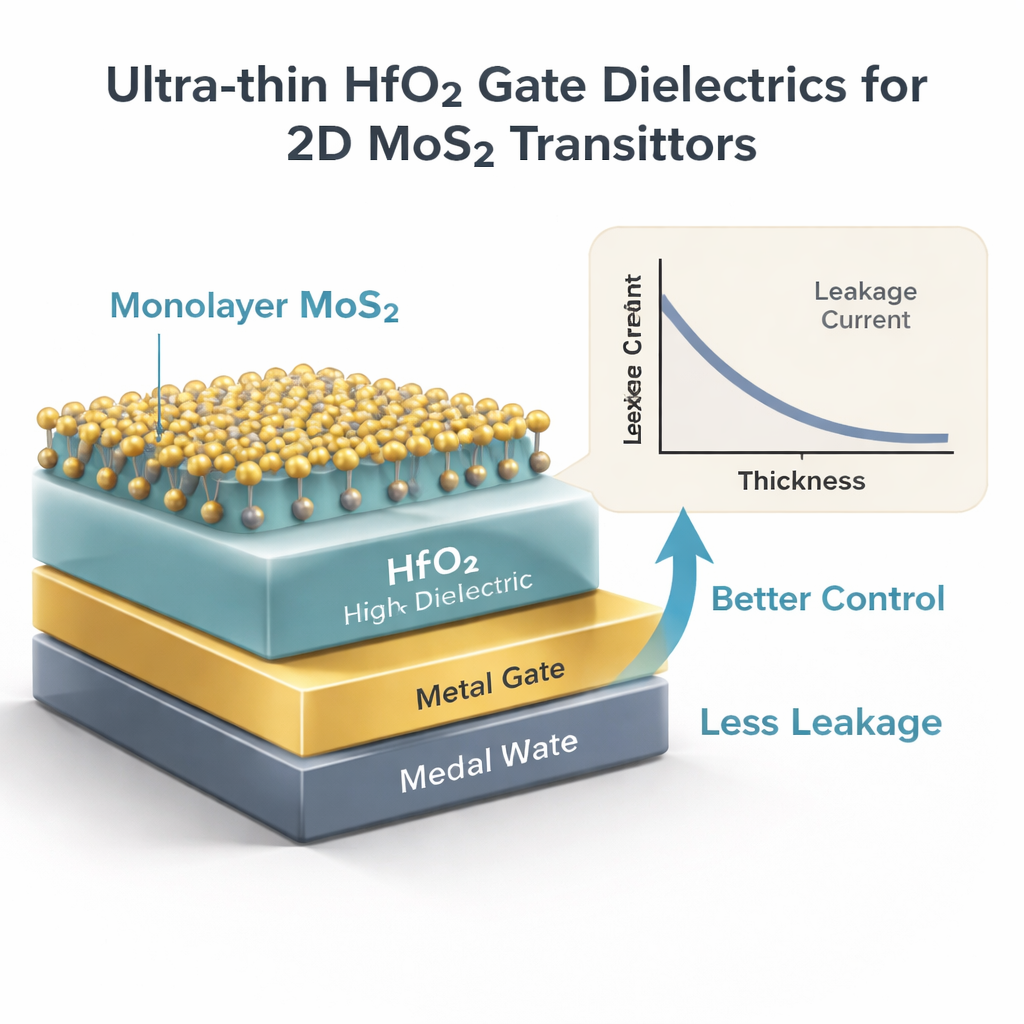
Atomik Ölçekte Kusurların Temizlenmesi
Konvansiyonel HfO2 büyümesi genellikle tek bir oksidasyon adımı kullanır ve bu, arkada birçok oksijen eksikliği bırakır. Bunlar elektronlar için kestirme yollar gibi davranır ve yalıtkan gücünü zayıflatır. MOALD yaklaşımında her büyüme döngüsü iki oksidasyon adımı içerir; önce ozon, sonra oksijen plazması uygulanır. Mikroskopi ve spektroskopi, bu ardışık işlemin oksijen boşluklarını keskin şekilde azalttığını ve 1,3 nanometre gibi ince katmanlarda bile daha düzgün, daha sürekli filmler ortaya çıkardığını gösteriyor. Bilgisayar simülasyonları bunu doğruluyor: kusurlar bol olduğunda malzemenin elektronik bant aralığı daralıyor ve aralığın içine ekstra durumlar giriyor; bu da bozulmayı kolaylaştırıyor. Kusurlar en aza indirildiğinde bant aralığı genişliyor, kaçak yolları baskılanıyor ve dielektriğin gücü geri kazanılıyor.
Düşük Kaçaklı Rekor İncelikte Yalıtım
Ekip bu ultratin filmleri basit metal–izolatör–metal test yapılarında ölçüyor. Fiziksel kalınlıkları çok küçük olmasına rağmen HfO2 katmanları, elektriksel kontrol açısından geleneksel silikon dioksitten çok daha ince bir katman gibi davranarak yalnızca 2,5 ångström eşdeğer oksit kalınlığı sağlıyor. Bu, uluslararası yol haritalarında geleceğin mantık cihazları için belirlenen iddialı hedeflerin altında. Kritik olarak, çalışma gerilimlerinde kaçak akımlar santimetrekare başına bir milyonda bir amperin altında kalıyor ve filmler bozulmadan önce 22 megavolt/santimetreden daha yüksek elektrik alanlarına dayanıyor. Egzotik perovskitler, moleküler kristaller ve diğer yüksek-κ oksitler gibi geniş bir deneysel alternatif yelpazesiyle karşılaştırıldığında, bu filmler önceki malzemelerin zorlandığı biçimde çok küçük etkin kalınlık, düşük kaçak ve güçlü bozulma davranışını bir arada sunuyor.
2B Transistörleri ve Devreleri Gerçeğe Daha Yaklaştırmak
Yeni dielektriğin yalnızca laboratuvar merakı olmadığını göstermek için yazarlar bunu tek tabakalı molibden disülfür (MoS2) ile entegre ediyor; MoS2 silisyumun muhtemel bir ardılı olarak geniş şekilde incelenen 2B bir yarıiletkendir. İki tip aygıt inşa ediyorlar: dielektriğin MoS2 eklenmeden önce büyütüldüğü kapı-ön transistörler ve mevcut bir MoS2 katmanının üzerine ince bir antimuan oksit “tohum” tabakası kullanılarak dielektriğin kapı-sonra olarak çökeltilmesiyle oluşturulan kapı-sonra transistörler. Her iki durumda da aygıtlar temiz anahtarlama gösteriyor; açık/kapalı akım oranları yaklaşık yüz milyon bir ve alt eşik eğimleri teorik termal limite yakın, neredeyse ideal değerler sergiliyor. Sadece 100 nanometre uzunluğunda kısa kanallı MoS2 transistörler, makul gerilimlerde mikron başına 260 mikroampere kadar iletim akım yoğunlukları sunarken kapı kaçakları son derece düşük kalıyor. 
Tek Aygıttan Tam Wafer Devrelere
Her yeni malzeme yaklaşımı için kilit bir test, bunun endüstride kullanılan büyük waferlere ölçeklenip ölçeklenemeyeceğidir. Burada araştırmacılar 1,3 nanometrelik HfO2 katmanlarını 200 °C gibi sadece düşük bir sıcaklıkta, endüstriyel çip üretimi ve hassas 2B malzemelerle uyumlu bir sıcaklıkta 8 inçlik bir silikon wafer üzerinde üniform şekilde büyütüyorlar. Bunun üzerine inverterler, AND, NAND ve NOR gibi temel mantık kapıları ve beş aşamalı halka osilatörleri içeren wafer ölçeğinde MoS2 mantık devreleri üretiyorlar. Bu devreler olağanüstü düşük besleme gerilimlerinde 0,1–0,2 volta kadar doğru çalışıyor, yüksek kazanç gösteriyor ve çok düşük statik güç tüketiyor; bu, ultra-ince, yüksek kaliteli dielektriklerin doğrudan düşük enerjili hesaplamaya nasıl dönüştüğünü ortaya koyuyor.
Günlük Elektroniğe Bunun Anlamı
Uzman olmayanlar için çıkarılacak sonuç şudur: yazarlar transistörde kullanılan en ince pratik elektrik yalıtkanlarından birini inşa etmiş ve bunu endüstri dostu yöntemlerle tam boyutlu waferler üzerinde üretebiliyorlar. Sadece birkaç atom tabakası malzemeyle akımı sıkı şekilde kontrol ederek bu HfO2 filmler, 2B MoS2 transistörlerin daha hızlı anahtarlamasına ve çok daha az enerji harcamasına yardımcı oluyor. Bu tür teknolojiler daha da geliştirilip ticari süreçlere entegre edilebilirse, daha küçük ve daha verimli elektroniğin trendini uzatabilir; mobil cihazlardan büyük ölçekli yapay zeka donanımına kadar uygulamalar için hem daha güçlü hem de daha az enerji tüketen gelecekteki çipleri mümkün kılabilir.
Atıf: Zhang, S., Zhang, T., Yu, H. et al. Wafer-scale high-κ HfO2 dielectric films with sub-5-Å equivalent oxide thickness for 2D MoS2 transistors. Nat Commun 17, 1888 (2026). https://doi.org/10.1038/s41467-026-68584-0
Anahtar kelimeler: yüksek-k dielektrikler, hafniyum oksit, 2B MoS2 transistörleri, ultratin kapı yalıtkanları, düşük güçlü elektronik