Clear Sky Science · sv
Förbättrad enhetlighet vid HARC-etsning genom kantbiasspänning och strukturella impedansvariationer i en rektangulär spänningsvåg
Varför chiptillverkare bryr sig om raka hål
Moderna minneschip pressar in mer information på mindre yta genom att borra miljarder ultravalsdjupa, penntunna hål i kisel. Dessa "hål med högt aspektförhållande" måste vara nästan perfekt vertikala; även liten lutning eller formförvrängning kan förstöra en komponent och kraftigt sänka produktionsutfallet. Denna artikel visar ett nytt sätt att hålla dessa hål raka och jämna över en hel kiselplatta genom att finjustera hur elektriska fält beter sig vid plattans kant under plasmaetsning.
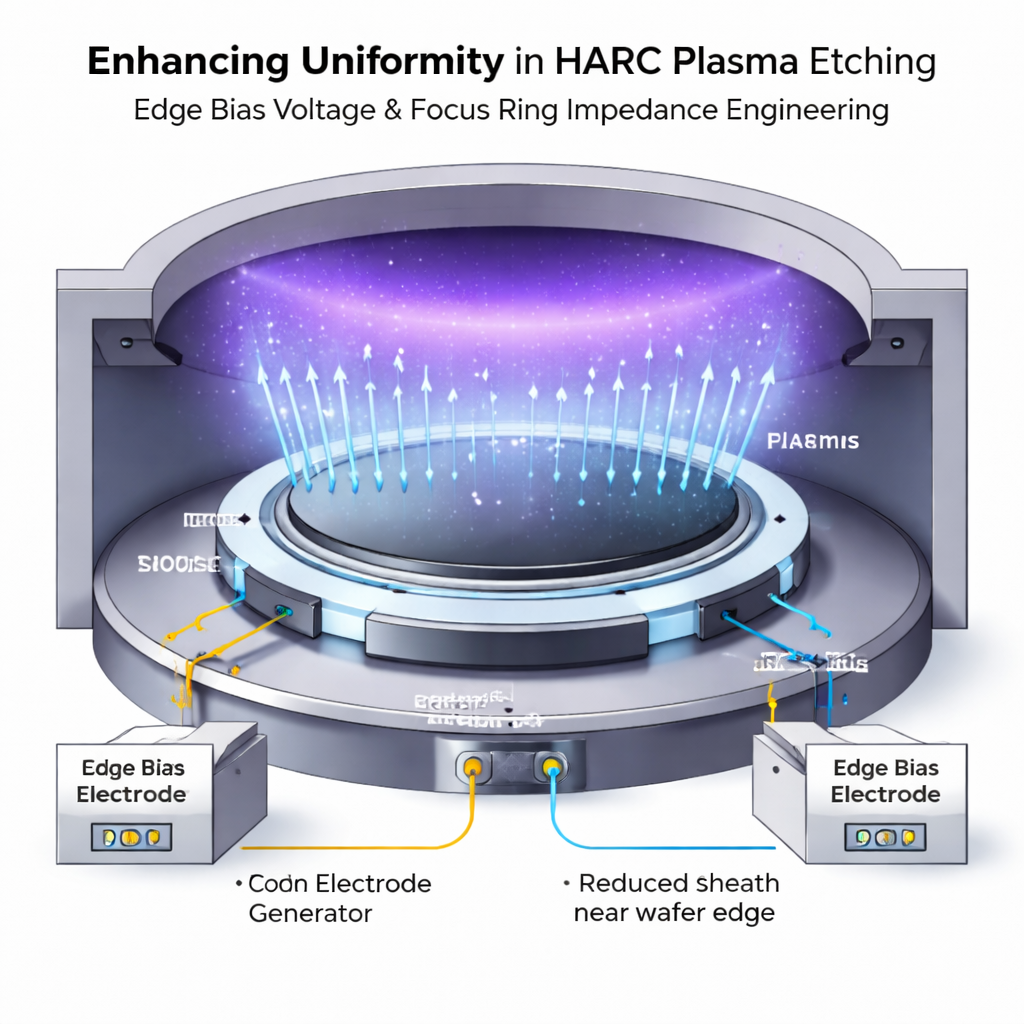
Problemet med plattans känsliga kant
För att karva mönster i en platta använder tillverkare ett plasma — en lysande gas fylld med energirika joner som slår bort material. Runt plattan sitter en förbrukningsbar "focus ring" som hjälper till att jämna ut plasmat från centrum till kant. Med tiden nöts denna ring bort av samma hårda miljö som etsar chippet. När den eroderas blir den elektriska skidan som styr jonerna mot plattan förvrängd vid kanten. Istället för att träffa rakt ner kommer jonerna in i en vinkel, vilket får hålen att luta mot centrum och anta elliptiska former. Detta förvränger inte bara de små kondensatorstrukturerna utan minskar även användbar yta och sänker avkastningen.
Att lägga till en styrbar "ratt" vid kanten
Forskarna tacklade detta genom att lägga till en oberoende styrd kantelektrod under focus ringen, matad med en rektangulär biasspänning separat från huvudspänningen till plattan. I stället för den vanliga mjuka sinusvågen växlar denna fyrkantliknande vågform skarpt mellan på och av, vilket håller spänningsskillnaden mellan plasmat och ytan mer konstant över tiden. Det jämnare trycket gör att jonerna anländer med ett snävare spektrum av energier och vinklar. Genom att noggrant höja kantbiasen kunde teamet stärka och omforma den elektriska skidan vid plattranden, dra jonbanorna mer vertikalt och återfå cirkulära, väl definierade spårprofiler även där focus ringen slitits ner.
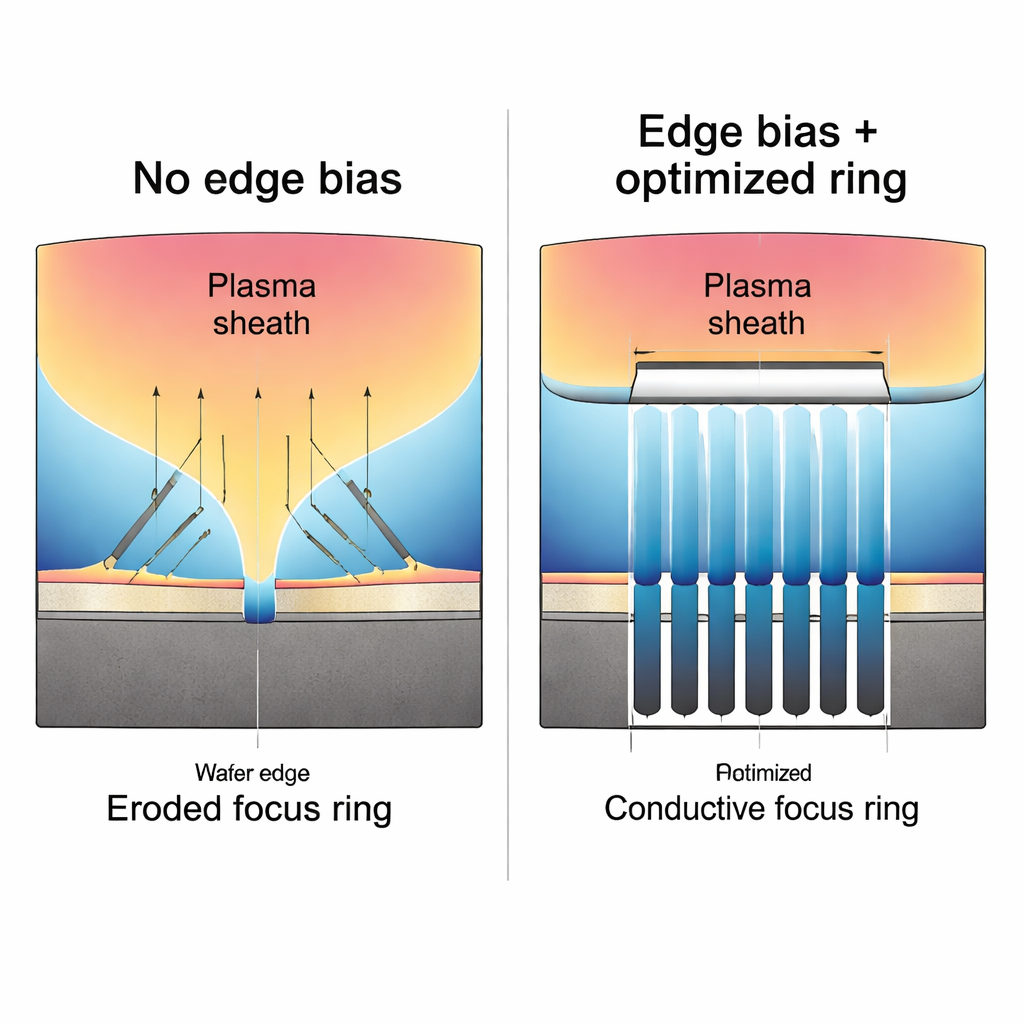
När mer effekt gör saken sämre
Att höja kantspänningen för mycket skapade dock ett nytt problem. Över ungefär 280–300 volt uppstod elektriska interaktioner mellan kant- och centerelektroderna som orsakade oönskad läckström genom plasmat. Övervakare visade ökande mismatcher mellan den spänning utrustningen försökte applicera och den faktiska spänningen som plattan upplevde, tillsammans med stigande strömmar i plattans område. Detta störde den noggrant inställda skidan, gjorde plasmat instabilt och återinförde icke‑uniform etsning: mittregionerna etsade snabbare, kanten saktade ner och hålformerna förvrängdes igen trots den högre kantbiasen.
Omarbetning av hårdvaran för att tygla fälten
För att återställa kontrollen vid höga spänningar ingenjörsgruppen omkonstruerade stapeln av isolerande och ledande delar kring plattan — särskilt materialen under och runt focus ringen. Genom att byta komponenter och ändra deras elektriska egenskaper justerade de impedansförhållandet mellan focus ring‑banan och plattans chuck. Ett högre förhållande (omkring 1,31) begränsade oönskad koppling mellan de två bias‑kretsarna, vilket gjorde att kantbiasen kunde göra sitt jobb utan att dra med sig centrum. Experiment visade att med denna optimerade konfiguration förblev spåren nästan cirkulära och vertikala även vid 300 volts kantbias, och etsningen hölls betydligt mer enhetlig över plattan. Datorsimuleringar bekräftade detta och visade hur olika focus ring‑material (kisel kontra kvarts) påverkar skidtjocklek, plasmadensitet och styrkan i det vertikala elektriska fältet.
Vad detta betyder för framtida minneschip
För icke‑specialister är huvudbudskapet att författarna har hittat ett sätt att "styra" de osynliga elektriska fälten vid en plattas kant så att plasmajonerna borrar rakare, mer konsekventa hål. Genom att kombinera en separat styrd, rektangulär kantbias med en elektriskt optimerad stödkonstruktion kan de både korrigera kantlutning och undvika instabiliteter som uppstår när spänningar pressas för högt. Denna metod bör hjälpa tillverkare att behålla precis etsning av djupa funktioner när minnescellernas dimensioner fortsätter att krympa, vilket förbättrar avkastning och tillförlitlighet i nästa generations halvledarenheter.
Citering: Park, C., Cho, J., Um, J. et al. Enhancing uniformity in HARC etching via edge bias voltage and structural impedance variations in a rectangular voltage waveform. Sci Rep 16, 5851 (2026). https://doi.org/10.1038/s41598-026-36323-6
Nyckelord: plasmaetsning, halvledartillverkning, högt aspektförhållande, kantbiasspänning, focus ring-design