Clear Sky Science · sv
Fourier-ptychografisk koherensscanningsinterferometri för 3D-morfologi hos hög-aspektförhållande och sammansatta mikrofåror
Insyn i små, djupa fåror
Moderna mikrochip och sensorer är fyllda med ultrasmala, ultradjupa spår—mikroskopiska fåror som kan vara 300 mikrometer djupa men bara omkring 10 mikrometer breda. Deras exakta tredimensionella form påverkar starkt hur enheter som trycksensorer, avancerade lysdioder och metaoptik fungerar. Fram till nu har klar avbildning av dessa dolda former inneburit antingen att provet skadas eller att man får suddiga, ofullständiga mätningar. I denna artikel presenteras en ny optisk metod som tittar genom materialet i stället för att spegla ljus från ytan, och som avslöjar skarpa 3D-kartor av dessa djupa strukturer utan att något skärs upp.
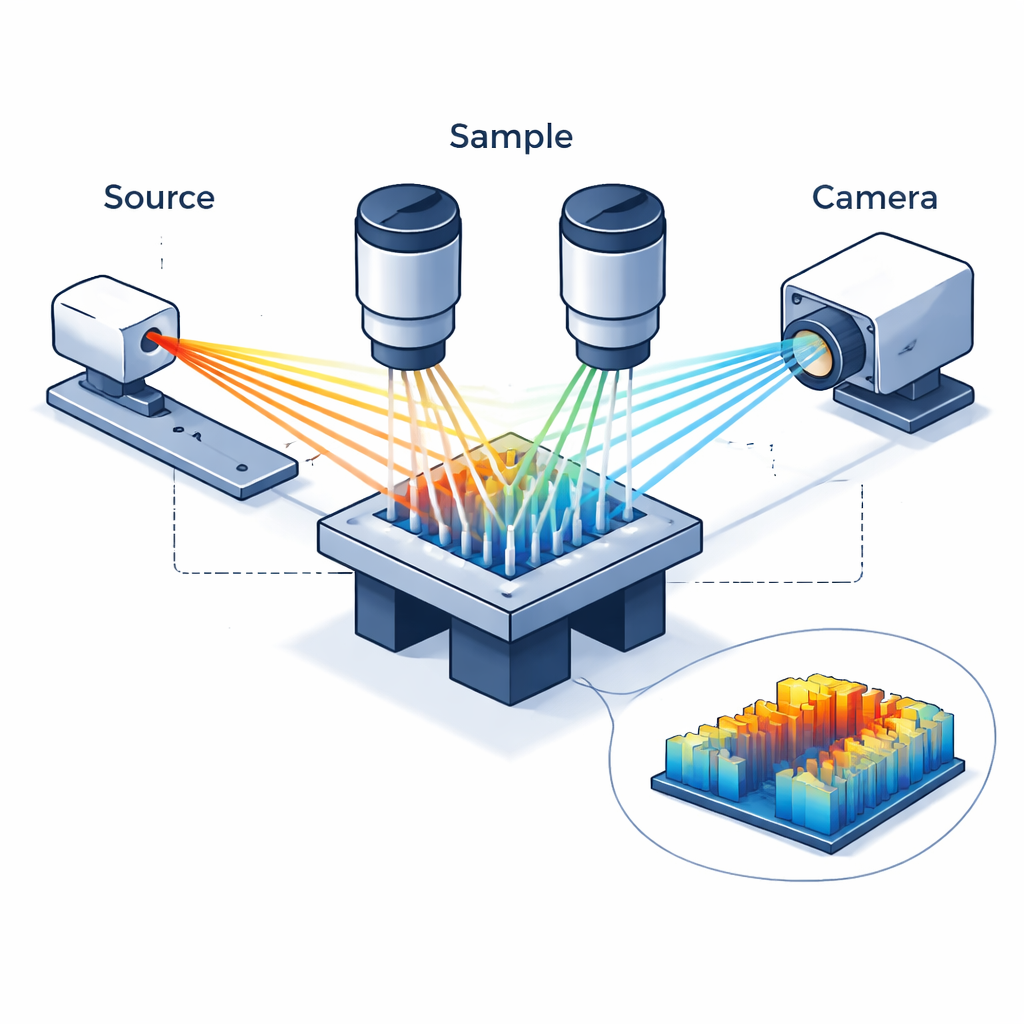
Varför djupa fåror spelar roll
Dessa fåror med högt aspektförhållande—mycket djupa i förhållande till sin bredd—är arbetskvalar i miniaturiserad teknik. I små maskiner kallade MEMS skapar de flexibla fjädrar och kamliknande strukturer för att mäta tryck eller rörelse. I avancerade lysdioder och optiska komponenter styr de ljus och ökar effektiviteten. Deras prestanda beror dock känsligt på detaljer som hur slät botten är, hur raka sidoväggarna är och om djup och bredd överensstämmer med designen inom en bråkdel av en mikrometer. Industrin förlitar sig ofta på elektronmikroskop för sådana kontroller, men de kräver skärning eller annan skadegörande provberedning, vilket är opraktiskt för rutinmässig, inline-inspektion.
Begränsningar hos dagens optiska verktyg
Icke-destruktiva optiska metoder försöker lösa detta genom att använda ljus i stället för att skära, men de har haft svårt med dessa extrema geometrier. En ledande teknik, koherensscanningsinterferometri, belyser ytan med bredbandsljus och analyserar interferensfransar för att bygga en höjdkarta. För grunda, öppna strukturer fungerar detta väl. Men i djupa och smala fåror reflekteras och sprids ljuset flera gånger mellan branta väggar. Resultatet blir utfrätta fransar och brusiga signaler, särskilt i fårans botten—just där ingenjörer behöver pålitliga mätningar. Användning av svagare, låg-vinkelbelysning kan förbättra signalens klarhet men på bekostnad av att tunna detaljer blir suddiga, vilket tvingar fram en kompromiss mellan upplösning och tillförlitlighet.
Tittar genom i stället för bara på
Författarnas angreppssätt, kallat Fourier-ptychografisk koherensscanningsinterferometri (FP-CSI), förändrar mätgeometrin. I stället för att reflektera ljus från provet skickar systemet nära-infrarött ljus genom en genomskinlig kiselwafer i en noggrant balanserad interferometer. En liten belysningspunkt flyttas sidledes så att provet undersöks av många något olika vinklar av nästan parallellt ljus. Eftersom ljuset passerar genom strukturen endast en gång och med liten divergens blir signalen mycket mindre förvrängd, och interferensfransarna förblir starka även vid botten av mycket djupa fåror. Metoden korrigerar sedan subtila distorsioner i de inspelade signalerna och kombinerar de många vinklade vyerna i frekvensdomänen, vilket effektivt syr ihop en större optisk apertur och återhämtar fina detaljer utan tunga, iterativa beräkningar.
Skarpa 3D-kartor av verkliga enheter
Med FP-CSI mätte teamet enskilda kiselfåror 300 mikrometer djupa med bredder ned till 10 mikrometer, samt komplexa flerskikts MEMS-trycksensorer med flera fårnivåer. I samtliga fall producerade metoden detaljerade tredimensionella kartor som stämde väl överens med korsjämförelser från elektronmikroskopi, men utan provskada. Fel i bredd och djup låg runt en procent eller mindre vid upprepade försök. Systemet kunde lösa linjefunktioner endast 1,3 mikrometer från varandra—i praktiken vid den fundamentala upplösningsgränsen som optiken sätter—och, viktigast, behöll nästan denna skärpa vid botten av modellfåror med aspektförhållanden större än 10:1, där standardreflekterande interferometrar i stort sett misslyckades.

Vad detta betyder för framtida tillverkning
För icke-specialister är huvudbudskapet att FP-CSI erbjuder ett sätt att ”se” den exakta 3D-formen hos extremt djupa och smala spår inuti transparenta mikroenheter snabbt och utan att öppna dem. Genom att kombinera styrkorna från två tidigare separata avbildningsidéer—interferensbaserad höjdmätning och flervinkel syntetisk avbildning—övervinner tekniken en länge bestående kompromiss mellan klarhet och tillförlitlighet. Detta gör den till ett lovande verktyg för nästa generations halvledartillverkning, MEMS-produktion och andra mikro-optoelektroniska system där osynliga, små former avgör om en enhet godkänns eller inte.
Citering: Li, Y., Yuan, Q., Huo, X. et al. Fourier ptychographic coherence scanning interferometry for 3D morphology of high aspect ratio and composite micro-trenches. Light Sci Appl 15, 93 (2026). https://doi.org/10.1038/s41377-026-02189-6
Nyckelord: 3D optisk metrologi, mikrofåror, MEMS-inspektion, interferometri, halvledartillverkning