Clear Sky Science · ru
Диэлектрические пленки HfO2 с высоким κ на подложке размером с пластину и эквивалентной толщиной оксида меньше 5 Å для транзисторов на 2D MoS2
Почему тоньше изоляторы важны для будущих чипов
Смартфоны, центры обработки данных и приложения ИИ зависят от крошечных электронных переключателей — транзисторов. Чтобы продолжать размещать всё больше таких переключателей на чипах при снижении энергопотребления, инженерам нужно уменьшать не только сами транзисторы, но и изолирующие слои, контролирующие их работу. В этой статье описан метод получения исключительно тонкой, высококачественной изолирующей пленки, которая при этом эффективно препятствует утечке тока, а также применение этой технологии на пластинах полного размера в передовых двухмерных (2D) транзисторных схемах.
Новый тип ультратонкого электрического барьера
В основе каждого современного транзистора — «затвор», который включает и выключает ток в канале. Между ними находится тонкий изолирующий слой, или диэлектрик. В течение многих лет отрасль использовала диоксид гафния (HfO2), так называемый материал с высоким κ, который обеспечивает сильное управление каналом без необходимости в большой физической толщине. Но перенос этой идеи в область нескольких атомарных слоев сталкивался с трудностями: пленки часто дают чрезмерную утечку или разрушаются под электрическим напряжением. Авторы предлагают улучшенный метод выращивания, названный множественной окислительной атомно-слойной депозицией (MOALD), который формирует HfO2 толщиной всего 1,3 нанометра — всего несколько атомов — при сохранении плотности и минимума дефектов, необходимых для надежной работы. 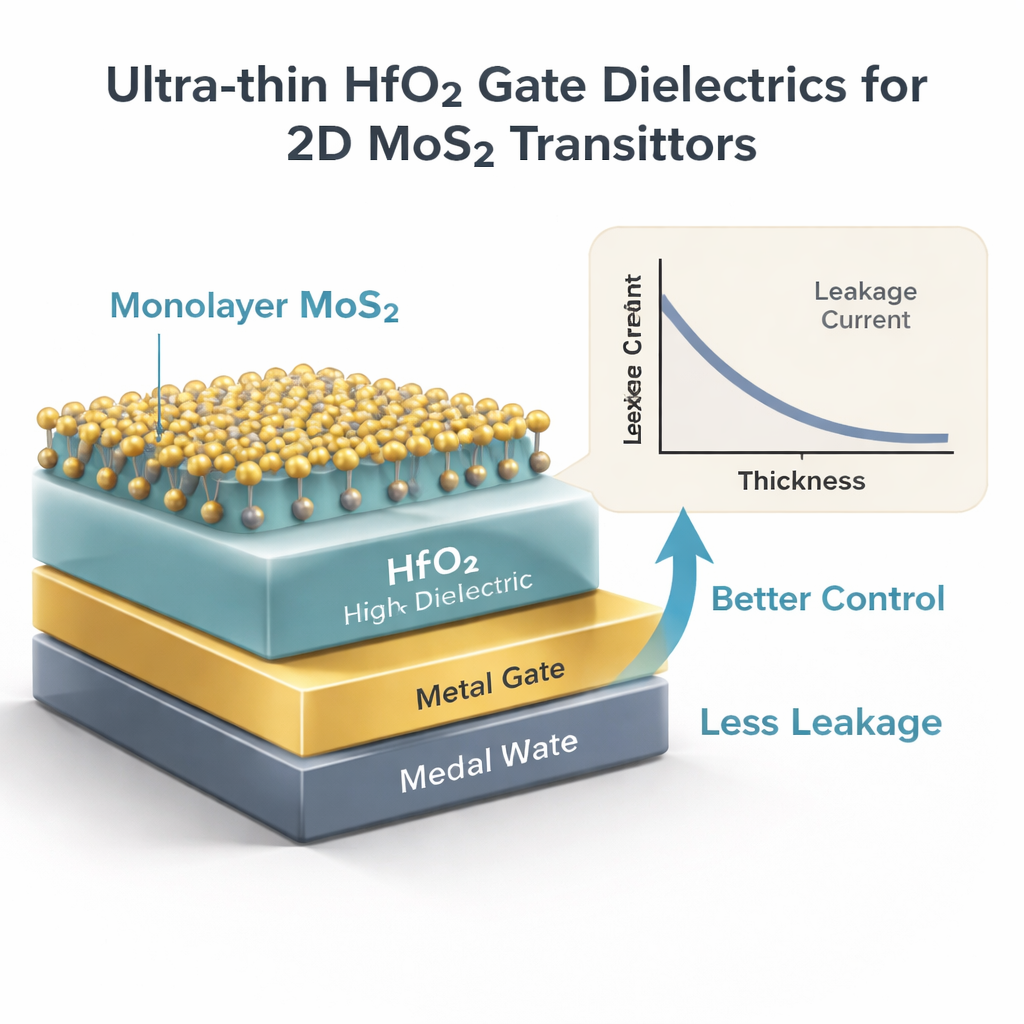
Устранение дефектов на атомном уровне
Традиционное выращивание HfO2 в лаборатории обычно использует один этап окисления, что оставляет множество недостатка кислорода. Они действуют как «короткие пути» для электронов, ослабляя изоляционные свойства. В подходе MOALD каждый цикл роста включает два этапа окисления: сначала озоном, затем кислородной плазмой. Микроскопия и спектроскопия показывают, что такое сочетание значительно снижает количество вакансий кислорода, давая более гладкие и сплошные пленки даже при толщине 1,3 нанометра. Компьютерные симуляции подтверждают эти выводы: при большом числе дефектов электронная запрещенная зона материала сужается и внутри нее появляются дополнительные состояния, что облегчает пробой. При минимуме дефектов ширина запрещенной зоны увеличивается, пути утечки подавляются, и диэлектрик восстанавливает свои свойства.
Рекордно тонкая изоляция с низкой утечкой
Команда измеряла эти ультратонкие пленки в простых структурах металл–диэлектрик–металл. Несмотря на их крошечную физическую толщину, слои HfO2 ведут себя как гораздо тонкий эквивалентный слой традиционного диоксида кремния с точки зрения электрического управления, достигая эквивалентной толщины оксида всего 2,5 ангстрема. Это ниже агрессивных целей, установленных международными дорожными картами для будущих логических устройств. Что важно, токи утечки остаются ниже одной миллионной ампера на квадратный сантиметр при рабочем напряжении, а пленки выдерживают электрические поля свыше 22 мегавольт на сантиметр до пробоя. По сравнению с широким набором экспериментальных альтернатив — такими как экзотические перовскиты, молекулярные кристаллы и другие оксиды с высоким κ — эти пленки сочетают очень малую эффективную толщину, низкую утечку и высокую прочность на пробой, чего предыдущим материалам было трудно достичь одновременно.
Приближение 2D-транзисторов и схем к реальности
Чтобы показать, что новый диэлектрик — не просто лабораторное открытие, авторы интегрируют его с монослоем дисульфида молибдена (MoS2), двумерным полупроводником, активно рассматриваемым как возможный преемник кремния. Они создают два типа устройств: транзисторы с предварительным формированием затвора (gate-first), где диэлектрик выращивают до добавления MoS2, и транзисторы с последующим формированием затвора (gate-last), где диэлектрик осаждают поверх уже существующего слоя MoS2 с использованием тонкого слоя оксида сурьмы в качестве «затравки». В обоих случаях устройства переключаются четко, с отношением токов включено/выключено порядка ста миллионов к одному и почти идеальными субпороговыми наклонами, близкими к теоретическому термическому пределу. Короткоканальные MoS2-транзисторы длиной всего 100 нанометров обеспечивают плотности тока в открытом состоянии до 260 микроампер на микрометр при умеренных напряжениях, при этом утечка через затвор остается чрезвычайно низкой. 
От отдельных устройств к схемам на целой пластине
Ключевой тест для любого нового материала — можно ли масштабировать подход до больших пластин, используемых в промышленности. Здесь исследователи выращивают свой слой HfO2 толщиной 1,3 нанометра равномерно по 8-дюймовой кремниевой пластине при температуре всего 200 °C, совместимой со стандартной производственной технологией чипов и с деликатными 2D-материалами. Поверх этого они изготовляют логические схемы на MoS2 в масштабе пластины, включая инверторы, базовые логические элементы AND, NAND и NOR, а также пятиступенчатые кольцевые генераторы. Эти схемы корректно работают при необычно низких напряжениях питания до 0,1–0,2 вольта, демонстрируют высокий коэффициент усиления и потребляют крошечную статическую энергию, что иллюстрирует, как ультратонкие, высококачественные диэлектрики напрямую переводятся в низкоэнергетические вычисления.
Что это значит для повседневной электроники
Для неспециалистов основной вывод таков: авторы создали один из самых тонких практических электрических изоляторов, когда-либо применявшихся в транзисторах, и научились производить его по пластинам полного размера с использованием методов, совместимых с промышленностью. Точный контроль тока при помощи всего нескольких атомарных слоев материала позволяет HfO2-пленкам заставлять 2D MoS2-транзисторы переключаться быстрее и тратить значительно меньше энергии. Если такие технологии удастся доработать и интегрировать в коммерческие процессы, они могут продлить тренд в сторону меньших и более эффективных электронных устройств, обеспечивая будущие чипы более мощными и экономичными для применения от мобильных устройств до масштабного аппаратного обеспечения для ИИ.
Цитирование: Zhang, S., Zhang, T., Yu, H. et al. Wafer-scale high-κ HfO2 dielectric films with sub-5-Å equivalent oxide thickness for 2D MoS2 transistors. Nat Commun 17, 1888 (2026). https://doi.org/10.1038/s41467-026-68584-0
Ключевые слова: диэлектрики с высоким k, оксид гафния, транзисторы на 2D MoS2, ультратонкие изоляторы затвора, низкоэнергетическая электроника