Clear Sky Science · nl
Verbeteren van uniformiteit bij HARC-etsen door rand-biasspanning en structurele impedantieverschillen in een rechthoekige spanningsgolfvorm
Waarom chipfabrikanten geven om rechte gaten
Moderne geheugenchips persen meer informatie in kleinere ruimtes door miljarden extreem diepe, potlooddunne gaten in silicium te boren. Deze "high-aspect-ratio"-gaten moeten vrijwel perfect verticaal zijn; zelfs een lichte helling of vervorming kan een apparaat onbruikbaar maken en de productopbrengst fors verlagen. Dit artikel toont een nieuwe manier om die gaten recht en uniform over een hele siliciumwafer te houden door de elektrische velden aan de rand van de wafer tijdens plasma-etsen fijn af te stemmen.
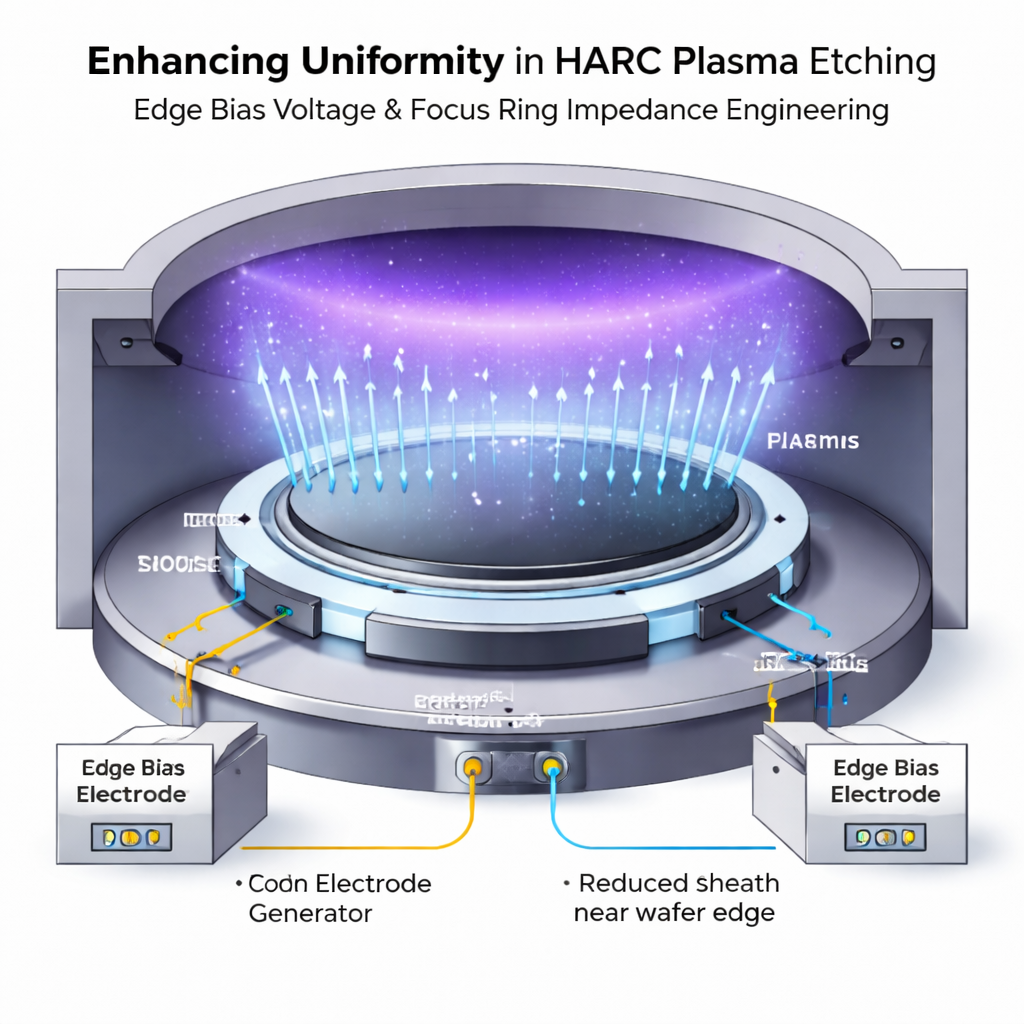
Het probleem met de fragiele rand van de wafer
Om patronen in een wafer te snijden gebruiken fabrikanten een plasma — een gloeigaste met energierijke ionen die materiaal wegblaast. Rond de wafer bevindt zich een offerschijf, de zogeheten "focusring", die helpt het plasma van midden tot rand gelijkmatig te houden. Na verloop van tijd wordt die ring door hetzelfde agressieve milieu dat de chip etst aangetast. Terwijl hij erodeert, raakt de elektrische sheath die ionen naar de wafer stuurt vervormd dicht bij de rand. In plaats van recht naar beneden te slaan, komen de ionen onder een hoek binnen, waardoor gaten naar het midden toe kantelen en in ellipsvorm rekken. Dit vervormt niet alleen de kleine condensatorstructuren, maar verkleint ook het bruikbare oppervlak en verlaagt de opbrengst.
Een bestuurbaar "stuurwiel" aan de rand toevoegen
De onderzoekers pakten dit aan door een onafhankelijk bestuurbare randelektrode onder de focusring te plaatsen, gevoed met een rechthoekige biasspanning die losstaat van de hoofdwafer-bias. In plaats van de gebruikelijke vloeiende sinusgolf schakelt deze vierkante-achtige golfvorm scherp tussen aan en uit, waardoor het spanningsverschil tussen het plasma en het oppervlak in de tijd constanter blijft. Die constantere duwkracht laat ionen met een smallere spreiding aan energieën en hoeken binnenkomen. Door de rand-bias zorgvuldig te verhogen, kon het team de elektrische sheath aan de rand van de wafer versterken en herschikken, zodat ionenbanen terug naar verticaal werden getrokken en ronde, goed gedefinieerde sleufprofielen herstelden, zelfs waar de focusring was versleten.
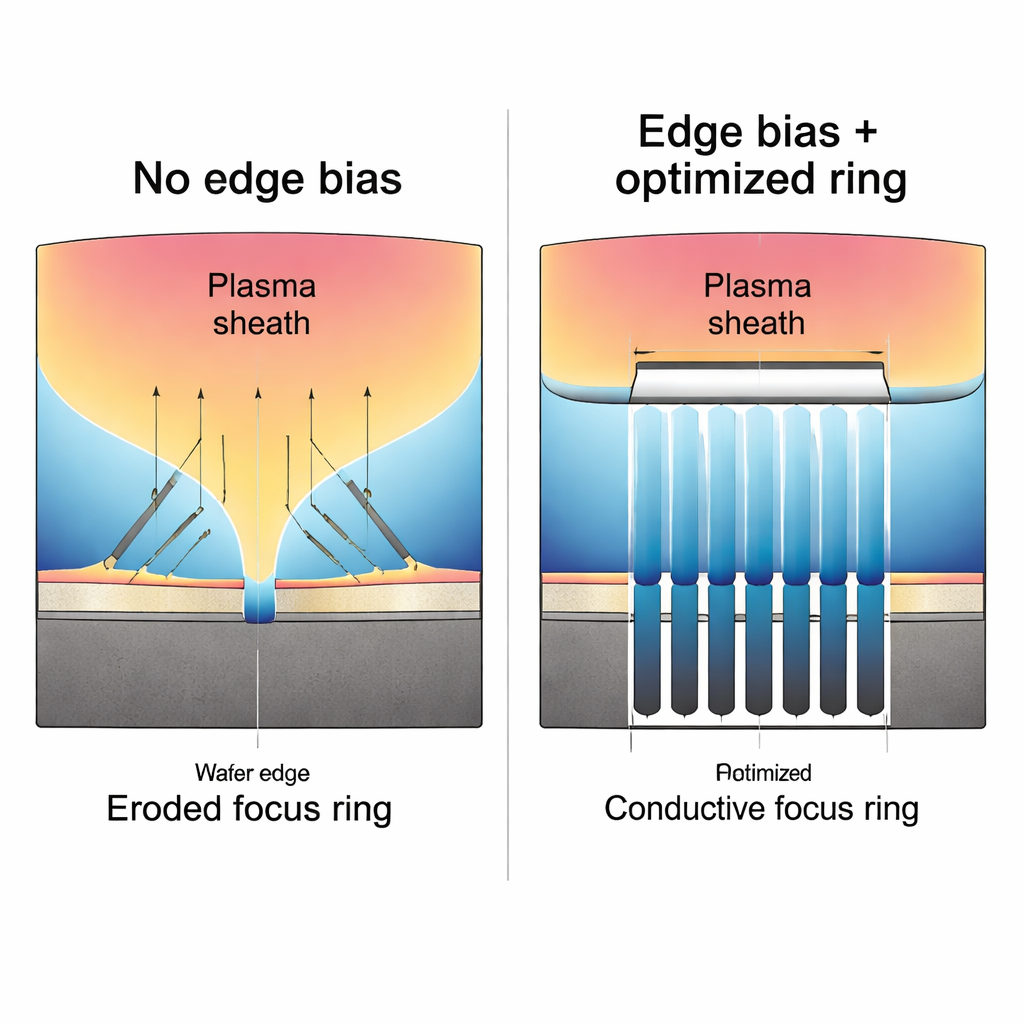
Wanneer meer vermogen het slechter maakt
Het te ver opvoeren van de randspanning gaf echter een nieuw probleem. Boven ongeveer 280–300 volt veroorzaakte de elektrische interactie tussen de rand- en centrale elektroden ongewenste lekkende stromen door het plasma. Meetapparatuur toonde toenemende afwijkingen tussen de spanning die de apparatuur probeerde toe te passen en de werkelijke spanning die de wafer zag, samen met stijgende stromen in het wafergebied. Dit verstoorde de zorgvuldig afgestemde sheath, maakte het plasma onstabiel en introduceerde opnieuw niet-uniform etsen: middengebieden werden sneller geëtst, de rand vertraagde, en de gatvormen raakten ondanks de hogere rand-bias weer vervormd.
Hardware opnieuw ontwerpen om de velden te temmen
Om de controle bij hoge voltages te herstellen, herontwierp het team de stapel isolerende en geleidendende onderdelen rond de wafer — in het bijzonder de materialen onder en rond de focusring. Door componenten te verwisselen en hun elektrische eigenschappen te veranderen, stelden ze de impedantieverhouding tussen het focusringpad en de waferchuck bij. Een hogere verhouding (ongeveer 1,31) beperkte ongewenste koppeling tussen de twee biascircuits, waardoor de rand-bias zijn werk kon doen zonder het centrum mee te slepen. Experimenten toonden dat met deze geoptimaliseerde configuratie de sleuven zelfs bij 300 volt rand-bias bijna cirkelvormig en verticaal bleven, en dat de etsnelheid veel uniformer over de wafer bleef. Computersimulaties ondersteunden dit beeld en onthulden hoe verschillende focusringmaterialen (silicium versus kwarts) de sheath-dikte, plasmadichtheid en de sterkte van het verticale elektrische veld veranderen.
Wat dit betekent voor toekomstige geheugenchips
Voor niet-specialisten is de kernboodschap dat de auteurs een manier hebben gevonden om de onzichtbare elektrische velden aan de rand van een wafer te "sturen" zodat plasma-ionen rechte, consistenter gaten boren. Door een afzonderlijk bestuurbare, rechthoekige rand-bias te combineren met een elektrisch geoptimaliseerde steunstructuur, kunnen ze zowel de randkanteling corrigeren als instabiliteiten vermijden die ontstaan bij te hoge spanningen. Deze aanpak zou fabrikanten moeten helpen om precieze, diepe structuren te blijven etsen naarmate geheugencellen blijven krimpen, wat de opbrengst en betrouwbaarheid van volgende-generatie halfgeleiderapparaten verbetert.
Bronvermelding: Park, C., Cho, J., Um, J. et al. Enhancing uniformity in HARC etching via edge bias voltage and structural impedance variations in a rectangular voltage waveform. Sci Rep 16, 5851 (2026). https://doi.org/10.1038/s41598-026-36323-6
Trefwoorden: plasma-etsen, halfgeleiderfabricage, hoge aspectverhouding, rand-biasspanning, focusringontwerp