Clear Sky Science · ja
長方形電圧波形におけるエッジバイアス電圧と構造インピーダンス変化によるHARCエッチング均一性の向上
なぜ半導体メーカーはまっすぐな穴を重視するのか
現代のメモリチップは、シリコンに対して何十億もの非常に深くて鉛筆のように細い穴を掘ることで、より多くの情報を小さな領域に詰め込んでいます。これらの「高アスペクト比」穴はほぼ垂直である必要があり、わずかな傾きや形状の歪みでも装置を損ない、生産歩留まりを大幅に下げてしまいます。本論文は、プラズマエッチング中にウェーハ端部で作用する電界の制御を微調整することで、シリコンウェーハ全体でこれらの穴をまっすぐかつ均一に保つ新しい手法を示します。
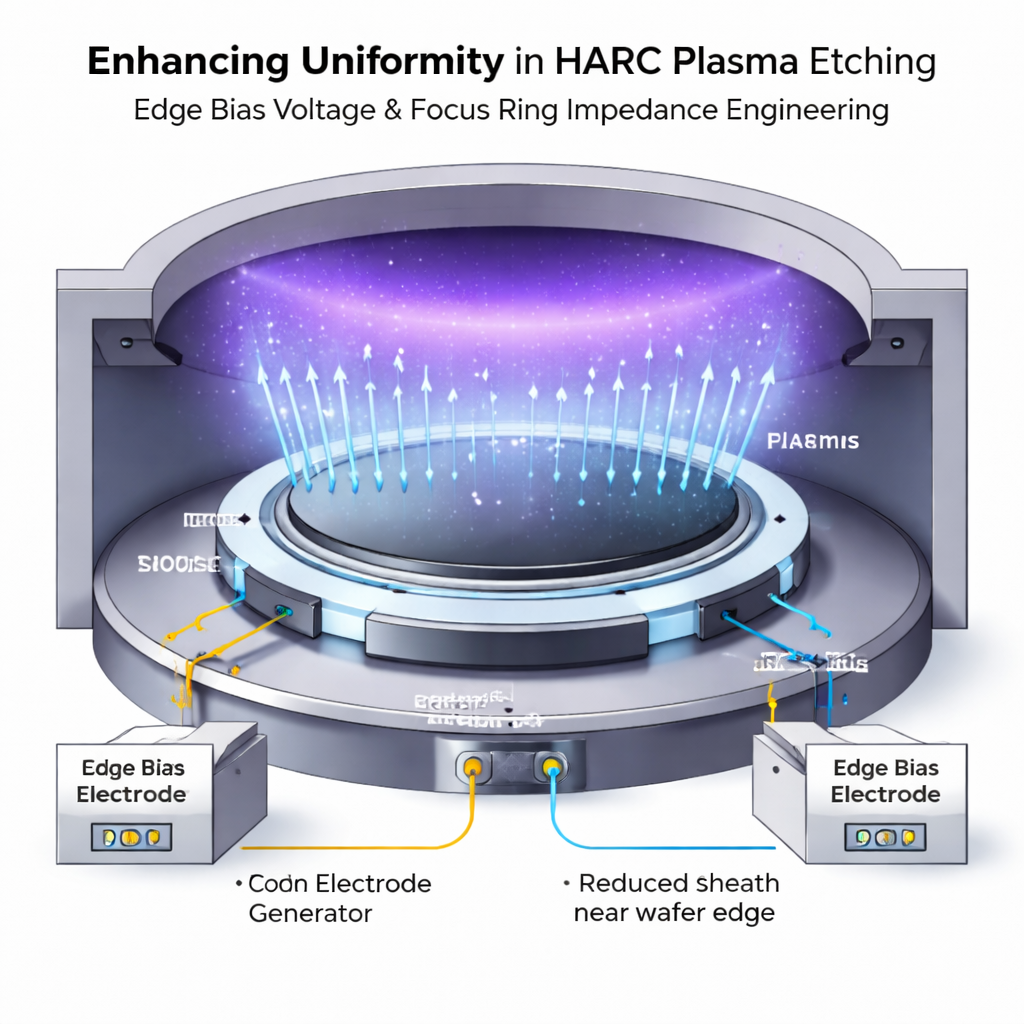
ウェーハの脆弱な境界部にある問題
ウェーハにパターンを刻むために、メーカーはプラズマ——高エネルギーイオンを多く含む発光するガス——を用います。ウェーハの周囲には、中心から端までプラズマを均一に保つのを助ける使い捨ての「フォーカスリング」が置かれています。時間とともに、このリングはエッチングと同じ過酷な環境により侵食されます。リングがすり減ると、イオンをウェーハへ導く電気シースが端部近くで歪みます。イオンは真下に衝突するのではなく斜めに到達し、穴が中心方向へ傾き、断面が楕円形に伸びてしまいます。これにより微小なコンデンサ構造が歪むだけでなく、使用可能面積が減少し歩留まりが低下します。
端部に制御可能な「ハンドル」を追加する
研究者らはこれに対処するため、フォーカスリングの下に独立制御可能なエッジ電極を追加し、メインのウェーハバイアスとは別に長方形に近いバイアス電圧を印加しました。通常の滑らかなサイン波ではなく、この方形に近い波形はオンとオフを急峻に切り替え、プラズマと表面間の電位差を時間的により一定に保ちます。より安定した駆動により、イオンはエネルギーと入射角の分布が狭くなります。エッジバイアスを慎重に上げることで、研究チームはウェーハ端部の電気シースを強化・再形成し、イオンの経路を垂直方向へ引き戻して、フォーカスリングが摩耗した領域でも円形で明瞭な溝断面を回復できました。
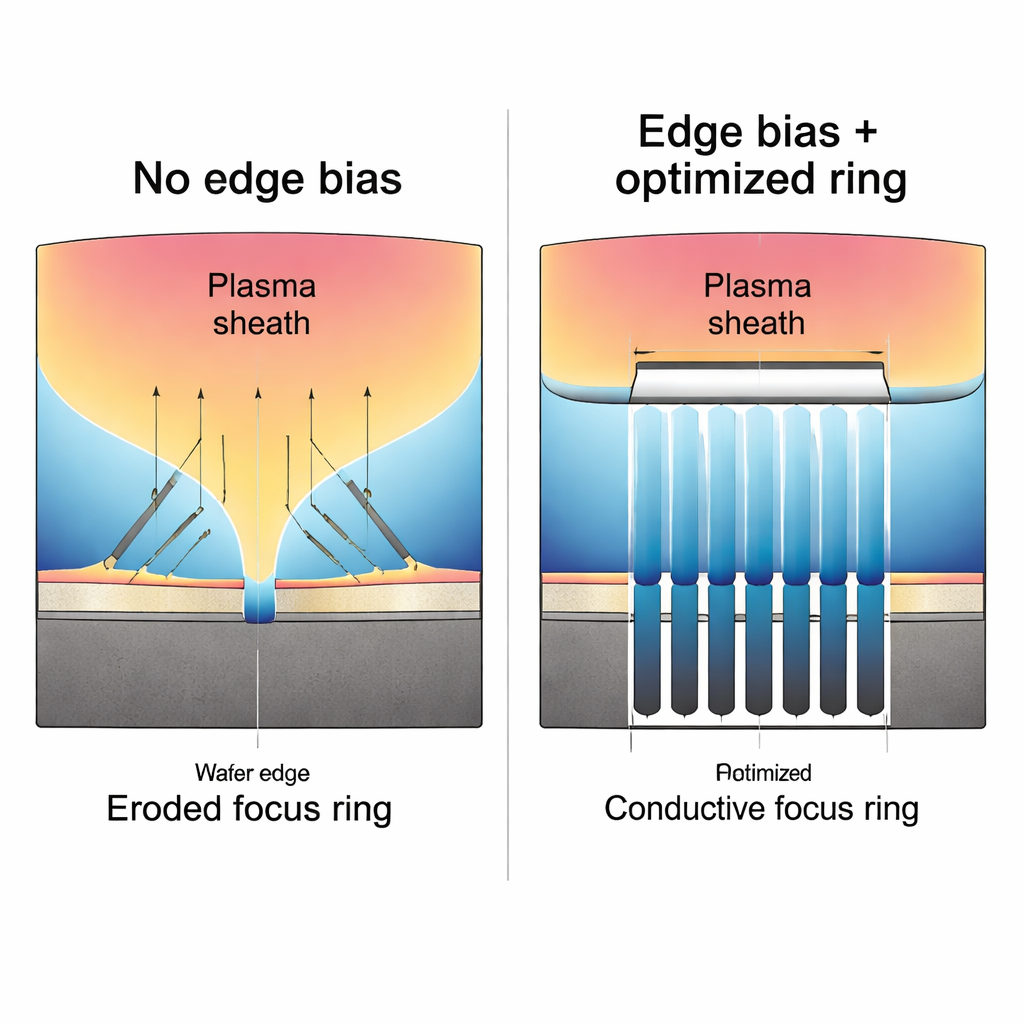
出力を上げすぎると状況が悪化する場合
しかし、エッジ電圧を上げすぎると新たな問題が生じました。約280〜300ボルトを超えると、エッジ電極と中心電極間の電気的相互作用によりプラズマを介した望ましくない電流漏れが発生しました。装置が印加しようとする電圧とウェーハで実際に観測される電圧との間に不一致が拡大し、ウェーハ領域の電流が上昇する様子がモニタで示されました。これにより綿密に調整されたシースが乱れ、プラズマが不安定になって非均一なエッチングが再発生しました:中央領域のエッチングが速くなり、端部は遅くなり、エッジバイアスを高めても再び穴形状が歪んでしまいました。
電界を抑えるためのハードウェア再設計
高電圧での制御を取り戻すために、チームはウェーハ周辺の絶縁部や導電部の積層構造、特にフォーカスリングの下および周囲の材料を再設計しました。部品を入れ替え、電気的特性を変更することで、フォーカスリング経路とウェーハチャック間のインピーダンス比を調整しました。より高い比(約1.31)は両バイアス回路間の望ましくない結合を抑え、エッジバイアスがセンターを巻き込むことなく機能するようにしました。実験では、この最適化構成により、エッジバイアス300ボルトでも溝はほぼ円形かつ垂直に保たれ、ウェーハ全体のエッチング速度の均一性が大幅に改善されることが示されました。数値シミュレーションもこれを裏付け、フォーカスリング材料(シリコンと石英)によってシース厚、プラズマ密度、垂直電界の強さがどのように変わるかを明らかにしました。
将来のメモリチップにとっての意義
専門外の方への結論は、著者らがウェーハ端部での目に見えない電界を「操舵」する方法を見つけ、プラズマイオンがよりまっすぐで一貫した穴を掘るようにできた、ということです。独立制御された長方形に近いエッジバイアスと電気的に最適化された支持構造を組み合わせることで、エッジの傾きを補正すると同時に、電圧を上げすぎたときに生じる不安定性を回避できます。この手法は、メモリセルがさらに微細化していく中で、深く正確な特徴を維持する助けとなり、次世代の半導体デバイスにおける歩留まりと信頼性の向上に寄与するはずです。
引用: Park, C., Cho, J., Um, J. et al. Enhancing uniformity in HARC etching via edge bias voltage and structural impedance variations in a rectangular voltage waveform. Sci Rep 16, 5851 (2026). https://doi.org/10.1038/s41598-026-36323-6
キーワード: プラズマエッチング, 半導体製造, 高アスペクト比, エッジバイアス電圧, フォーカスリング設計