Clear Sky Science · ja
2D MoS2トランジスタ向け、サブ5Å相当酸化膜厚を実現するウェーハスケール高κ HfO2 誘電膜
なぜ将来のチップで絶縁膜を薄くすることが重要なのか
スマートフォン、データセンター、AIはすべてトランジスタと呼ばれる小さな電子スイッチに依存しています。これらのスイッチをチップ上にさらに詰め込みつつエネルギー消費を削減するには、トランジスタ本体だけでなくその動作を制御する絶縁層も小型化する必要があります。本論文は、電気的リークを抑えつつ極めて薄く高品質な絶縁膜を作製する手法と、それを最先端の二次元(2D)トランジスタ回路でウェーハ全体にわたって適用する技術を説明します。
新しいタイプの超薄電気バリア
現代のトランジスタの中心には、チャネルを通る電流をオン/オフする「ゲート」があります。その間に薄い絶縁層(誘電体)が位置します。近年、ハフニウム酸化物(HfO2)と呼ばれる高κ材料が用いられてきました。これは物理的に厚くしなくてもチャネルを強く制御できるためです。しかし、原子数層レベルの薄さまでこのアプローチを推し進めるのは困難で、膜が過度にリークしたり電界で破壊されたりする問題が頻出します。著者らは多重酸化原子層堆積(MOALD)と呼ぶ改良成長法を導入し、わずか1.3ナノメートル—数原子層に相当する厚さのHfO2膜を、致密で欠陥の少ない状態で作製することに成功しました。 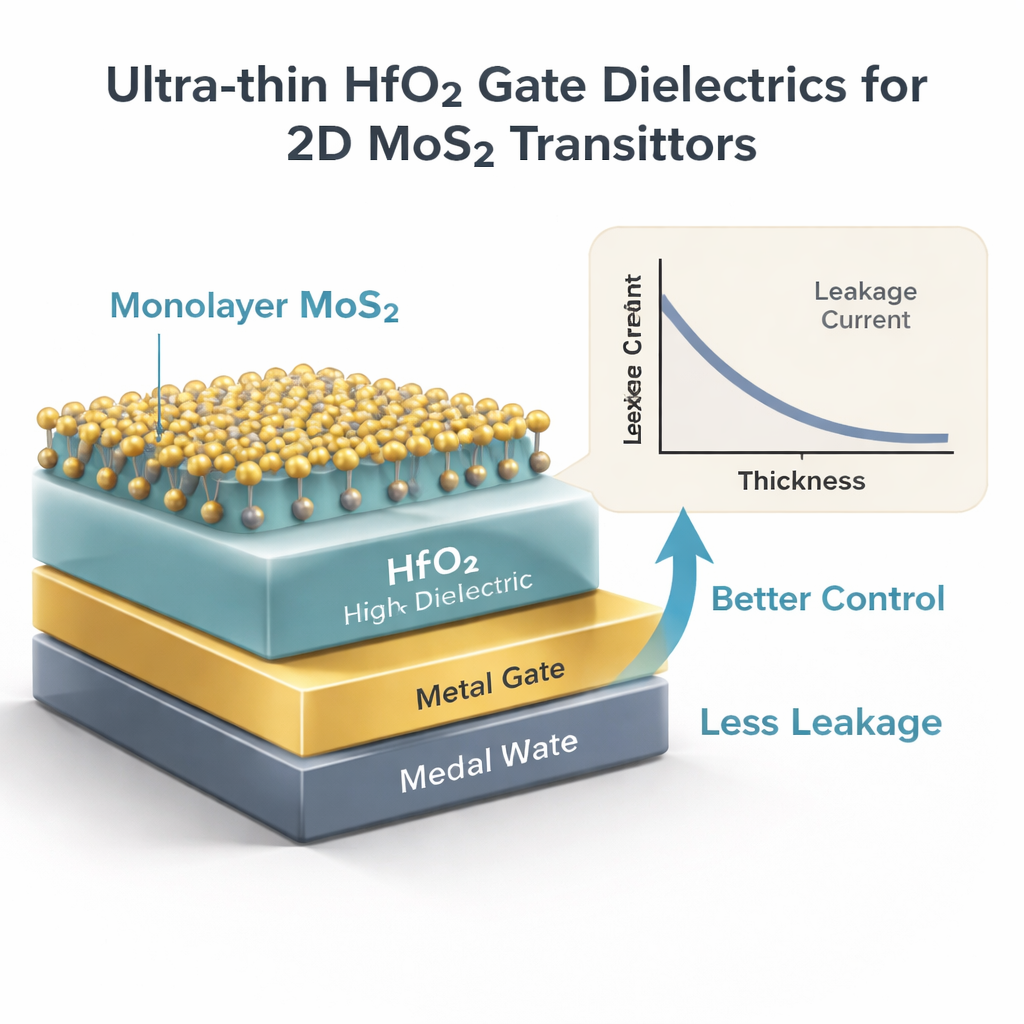
原子スケールで欠陥を取り除く
従来のHfO2成長では単一の酸化ステップを用いることが多く、多くの酸素欠乏欠陥が残ります。これらは電子の近道となり絶縁性を弱めます。MOALD手法では、各成長サイクルにオゾンと続けて酸素プラズマという二段階の酸化を含めます。顕微鏡や分光分析は、この連続処理が酸素空孔を大幅に減らし、1.3ナノメートルという薄さでも滑らかで連続した膜をもたらすことを示しています。計算機シミュレーションもこれを裏付けます:欠陥が多いと材料の電子バンドギャップが狭まり、ギャップ内に余分な状態が現れて破壊が起きやすくなります。欠陥が最小化されるとバンドギャップが広がり、リーク経路が抑制されて誘電体の強度が回復します。
低リークの記録的薄膜絶縁
研究チームはこれらの超薄膜を単純な金属–絶縁体–金属の試験構造で評価しました。物理的厚さは非常に薄いにもかかわらず、HfO2層は電気的制御の点で従来の二酸化ケイ素よりはるかに薄い層と同等に振る舞い、相当酸化膜厚(EOT)わずか2.5オングストロームを達成しました。これは将来のロジックデバイスに関する国際的なロードマップで提示されている厳しい目標を下回ります。重要なのは、動作電圧での漏れ電流が平方センチメートル当たり10^-6アンペア以下に抑えられ、膜は破壊に至るまで22メガボルト毎センチメートルを超える電界に耐える点です。ペロブスカイトや分子結晶、その他の高κ酸化物など多様な実験的代替材料と比較しても、これらの膜は非常に小さい有効厚さ、低リーク、強い破壊耐性を組み合わせており、従来材料が苦戦してきた特性の両立を示しています。
2Dトランジスタと回路を現実に近づける
新しい誘電体が単なる実験室の興味にとどまらないことを示すため、著者らはそれをモノレイヤーの二硫化モリブデン(MoS2)と統合しました。MoS2はシリコンの後継候補として広く研究されている2D半導体です。彼らは2種類のデバイスを作製しました:誘電体を先に成長してからMoS2を付加するゲートファーストトランジスタと、既存のMoS2層上に薄いアンチモン酸化物“シード”層を介して誘電体を堆積するゲートラストトランジスタです。どちらの場合もデバイスはクリーンにスイッチし、オン/オフ電流比は約1億、しきい値付近のサブスレッショルド傾斜は理論上の熱限界に近いほぼ理想的な値を示しました。チャネル長100ナノメートルの短チャネルトランジスタは控えめな電圧でマイクロアンペア級の高いオン電流密度(最大260 μA/μm)を達成し、ゲートリークは極めて低く保たれました。 
単一デバイスからウェーハ全体の回路へ
新材料アプローチの重要な試金石は、それが産業で用いられる大口径ウェーハにスケールできるかどうかです。本研究では、研究者らは1.3ナノメートルのHfO2層を8インチシリコンウェーハ全体にわたり均一に200 °Cというチップ製造やデリケートな2D材料と両立する低温で成長させました。その上にウェーハスケールのMoS2ロジック回路を作製し、インバータやAND、NAND、NORといった基本論理ゲート、5段のリングオシレータを含む回路を実現しました。これらの回路は0.1–0.2ボルトという異例に低い供給電圧で正常に動作し、高ゲインで極めて小さな静的消費電力を示し、超薄で高品質な誘電体が低エネルギー計算に直結することを示しています。
日常のエレクトロニクスにとっての意義
専門外の読者への要点は次のとおりです。著者らはトランジスタに実用的に使える中でも最も薄い電気絶縁体の一つを作り、それを産業に適した手法でウェーハ全体に製造できることを実証しました。わずか数原子層の材料で電流を精密に制御することで、これらのHfO2膜は2D MoS2トランジスタのスイッチングを高速化し、エネルギー損失を大幅に低減します。こうした技術がさらに洗練され商業プロセスに統合されれば、より小型で効率の良いエレクトロニクスの流れを延長し、モバイル機器から大規模AIハードウェアに至るまで、より高性能で省エネルギーな将来のチップをもたらす可能性があります。
引用: Zhang, S., Zhang, T., Yu, H. et al. Wafer-scale high-κ HfO2 dielectric films with sub-5-Å equivalent oxide thickness for 2D MoS2 transistors. Nat Commun 17, 1888 (2026). https://doi.org/10.1038/s41467-026-68584-0
キーワード: 高κ誘電体, 酸化ハフニウム, 2D MoS2トランジスタ, 超薄型ゲート絶縁膜, 低消費電力エレクトロニクス