Clear Sky Science · ja
高アスペクト比および複合マイクロトレンチの3D形状計測のためのフーリエピーティグラフィック干渉計コヒーレンススキャン法
微小な深い溝をのぞく
現代のマイクロチップやセンサーには、幅が約10マイクロメートルでありながら深さが300マイクロメートルにも達するような、極めて狭く深い溝が多数含まれています。これらの三次元形状は、圧力センサー、高度な発光ダイオード、メタオプティクスなどデバイスの性能に大きく影響します。これまでは、これらの隠れた形状を鮮明に見るために、試料を切断したり損傷したりするか、あるいはぼやけた不完全な測定を受け入れる必要がありました。本論文は、材料の表面で光を反射させる代わりに内部を透過して観察する新しい光学的手法を紹介し、何も切断せずに深い特徴の鮮明な3Dマップを明らかにします。
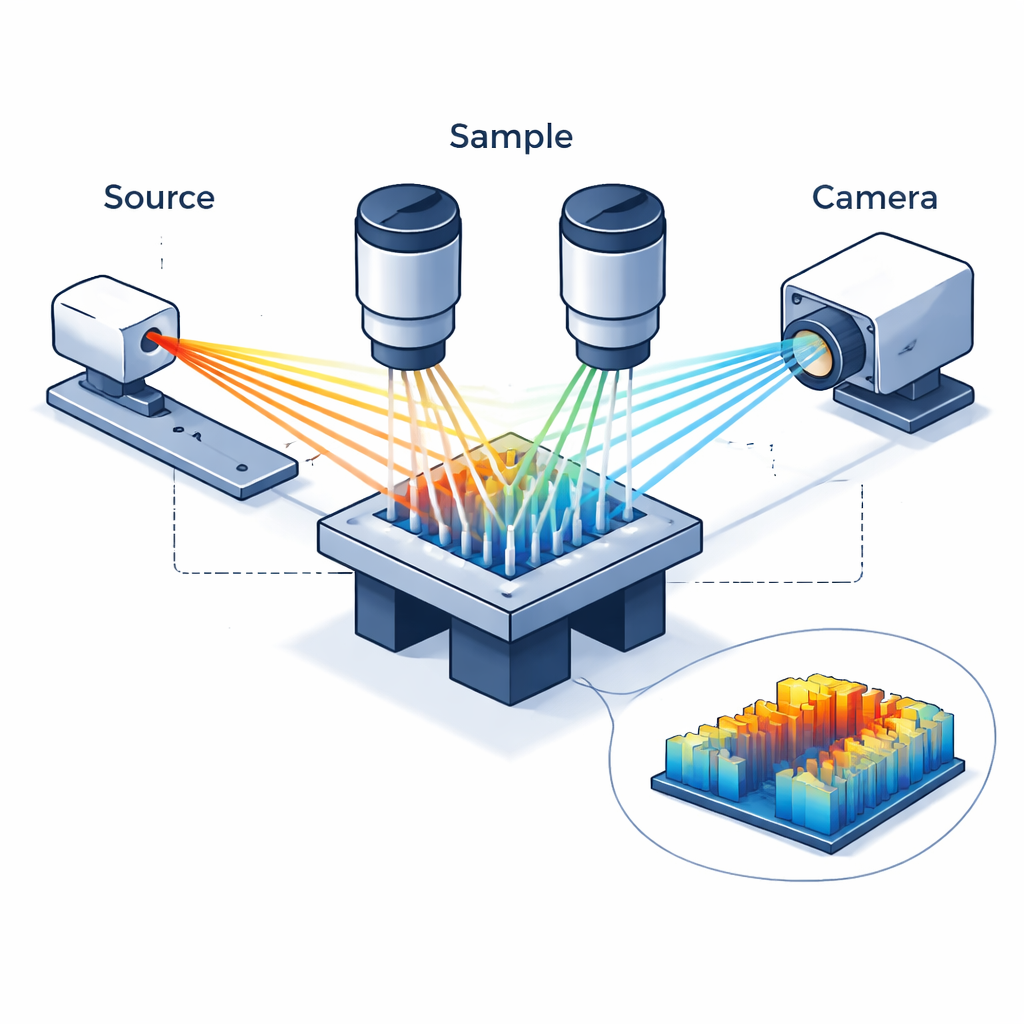
深い溝が重要な理由
これらの高アスペクト比トレンチは、幅に比べて非常に深い構造で、小型化技術の要所です。MEMSと呼ばれる微小機械では、可撓性のあるスプリングや櫛状の構造を作り、圧力や運動を計測します。先進的なLEDや光学部品では、光を導いたり効率を高めたりする役割を果たします。ただし、底面の滑らかさ、側壁の直線性、設計どおりの深さや幅が数分の一マイクロメートル単位で守られているかどうかといった細部に性能が敏感に依存します。業界ではこうした検査に電子顕微鏡を使うことが多いですが、試料の切断や損傷が必要で、ライン内のルーティン検査には不向きです。
現在の光学手法の限界
非破壊の光学的手法は切断の代替になり得ますが、極端な形状に対しては困難がありました。代表的な手法であるコヒーレンススキャン干渉計は、広帯域光を表面に照射し干渉縞を解析して高さマップを作ります。浅く開いた構造ではうまく機能します。しかし深く狭いトレンチでは、急峻な側壁間で光が何度も反射・散乱するため、干渉縞がぼやけ、特にトレンチ底部で信号がノイズに埋もれます。低角度の弱い照明を用いると信号は改善しますが、微細なディテールがぼやけるため、解像度と信頼性の間でトレードオフを強いられてきました。
単に表面を見るのではなく透かして見る
著者らのアプローチは、フーリエピーティグラフィック・コヒーレンススキャン干渉計(FP-CSI)と呼ばれ、測定の幾何を変えます。試料からの反射ではなく、透明なシリコンウェハーを近赤外光で透過させ、バランスされた干渉計で観測します。ごく小さな照明スポットを横方向にずらし、ほぼ平行な光をわずかに異なる角度で多数照射してサンプルを走査します。光が構造を一度だけ通過し、発散が小さいため、信号の歪みが大幅に減り、非常に深いトレンチの底面でも干渉縞が強く保たれます。その後、記録された信号の微妙な歪みを補正し、周波数領域で多数の角度ビューを結合することで、より大きな合成開口を実現し、重い反復計算に頼らずに細部を復元します。
実デバイスで得られた鮮明な3Dマップ
FP-CSIを用いて、研究チームは幅が約10マイクロメートルの単一シリコントレンチ(深さ300マイクロメートル)や、複数レベルのトレンチを含む多層MEMS圧力センサを計測しました。すべてのケースで、本手法は電子顕微鏡によるクロスチェック測定と良く一致する詳細な3次元マップを生成し、試料を損傷することはありませんでした。幅や深さの誤差は繰り返し試験で約1%以下に収まりました。システムは光学的に定められた基本的な解像度限界に近い、わずか1.3マイクロメートル離れた線状特徴を分解でき、重要な点として、標準的な反射型干渉計がほとんど失敗するようなアスペクト比10:1以上のモデルトレンチの底部でもほぼ同等の鮮明さを維持しました。

今後の製造にとっての意義
非専門家向けに要約すると、FP-CSIは透明なマイクロデバイス内部の極めて深く狭い溝の正確な3D形状を、迅速かつ非破壊で「見る」手段を提供します。干渉に基づく高さ測定と多角度合成イメージングという、これまで別々だった二つの強みを組み合わせることで、鮮明さと信頼性の間に長年存在した妥協を克服します。これにより、次世代の半導体製造、MEMS生産、その他微小光電デバイスにおいて、目に見えない微小形状が合否を決める場面で有望なツールとなります。
引用: Li, Y., Yuan, Q., Huo, X. et al. Fourier ptychographic coherence scanning interferometry for 3D morphology of high aspect ratio and composite micro-trenches. Light Sci Appl 15, 93 (2026). https://doi.org/10.1038/s41377-026-02189-6
キーワード: 3D 光計測, マイクロトレンチ, MEMS 検査, 干渉計測, 半導体製造