Clear Sky Science · it
Film dielettrici HfO2 ad alto κ su scala di wafer con spessore equivalente di ossido sotto i 5 Å per transistor 2D a base di MoS2
Perché isolanti più sottili contano per i chip del futuro
Smartphone, data center e intelligenza artificiale dipendono tutti da minuscoli interruttori elettronici chiamati transistor. Per continuare a inserire sempre più di questi interruttori nei chip riducendo il consumo energetico, gli ingegneri devono ridurre non solo le dimensioni dei transistor ma anche gli strati isolanti che ne controllano il comportamento. Questo articolo descrive un metodo per realizzare un film isolante estremamente sottile e di alta qualità che comunque blocca le perdite elettriche, e per applicarlo su wafer a grande superficie in circuiti transistor bidimensionali (2D) all’avanguardia.
Un nuovo tipo di barriera elettrica ultrassottile
Al centro di ogni transistor moderno c’è un “gate” che accende e spegne la corrente attraverso un canale. Tra loro si trova uno strato isolante sottile, o dielettrico. Per anni l’industria ha utilizzato l’ossido di afnio (HfO2), un materiale cosiddetto ad alto κ che consente un forte controllo del canale senza richiedere uno spessore fisico elevato. Ma spingere questo approccio nella dimensione di poche cellule atomiche è stato difficile: i film spesso presentano perdite di corrente e rotture sotto stress elettrico. Gli autori introducono un metodo di crescita migliorato, chiamato deposizione atomica a strati con ossidazione multipla (MOALD), che produce film di HfO2 spessi solo 1,3 nanometri—appena pochi atomi—mantenendoli comunque densi e poveri di difetti tanto da funzionare in modo affidabile. 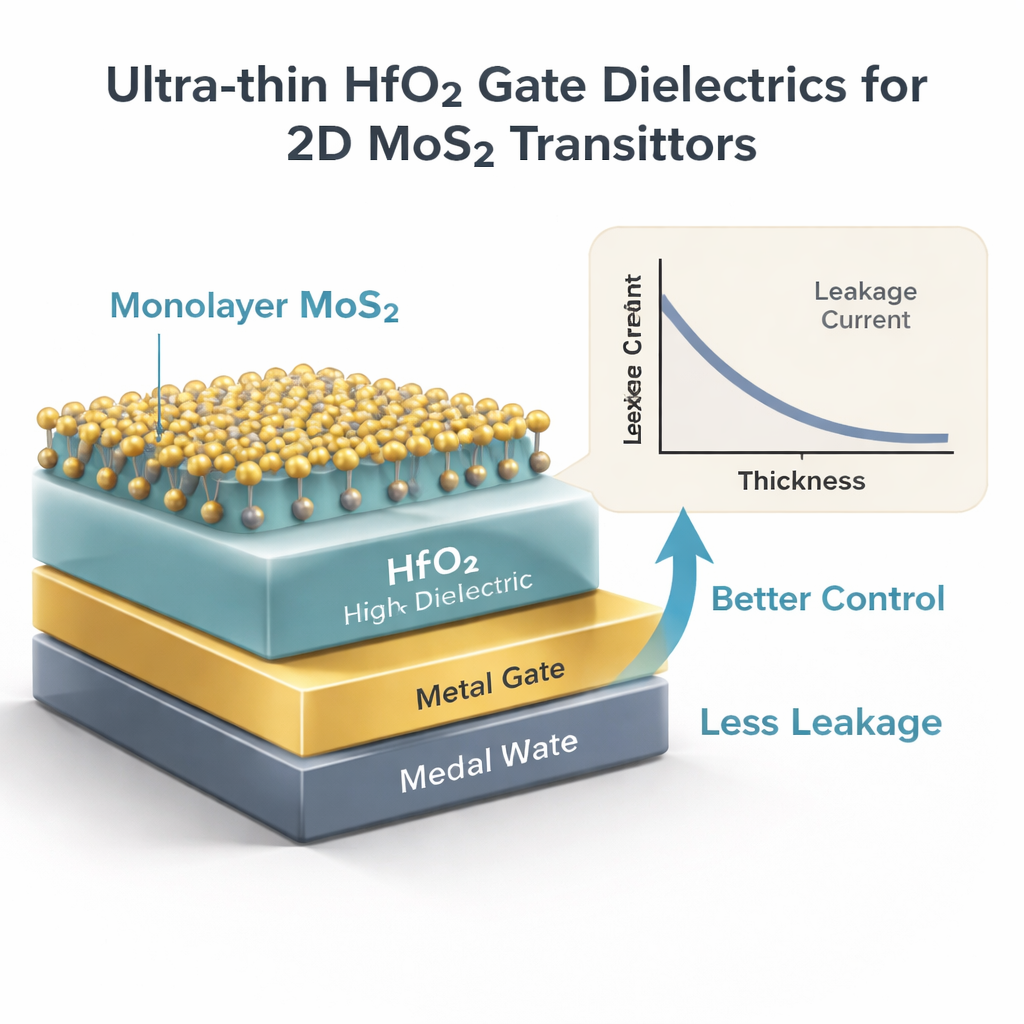
Ripulire i difetti su scala atomica
La crescita convenzionale di HfO2 in laboratorio di solito impiega un singolo passaggio di ossidazione, che lascia molti difetti da mancanza di ossigeno. Questi agiscono come scorciatoie per gli elettroni, indebolendo la capacità isolante. Nell’approccio MOALD, ogni ciclo di crescita include due passaggi di ossidazione, prima con ozono e poi con un plasma di ossigeno. Microscopia e spettroscopia mostrano che questo trattamento tandem riduce nettamente le vacanze di ossigeno, producendo film più lisci e continui anche a 1,3 nanometri. Simulazioni al computer confermano questi risultati: quando i difetti sono numerosi, il gap elettronico del materiale si riduce e compaiono stati addizionali all’interno del gap, facilitando la rottura. Quando i difetti sono minimizzati, il gap si amplia e le vie di perdita vengono soppresse, ripristinando la robustezza del dielettrico.
Isolamento record e bassa perdita
Il gruppo misura questi film ultrassottili in strutture di prova metal–isolante–metal semplici. Nonostante il loro esiguo spessore fisico, gli strati di HfO2 si comportano come uno strato molto più sottile dell’usuale biossido di silicio in termini di controllo elettrico, raggiungendo uno spessore equivalente di ossido di appena 2,5 ångström. Questo è al di sotto degli obiettivi ambiziosi definiti dalle roadmap internazionali per i dispositivi logici futuri. Fondamentale è che le correnti di perdita rimangono sotto il milionesimo di ampere per centimetro quadrato alle tensioni operative, e i film sopportano campi elettrici superiori a 22 megavolt per centimetro prima della rottura. Rispetto a una vasta gamma di alternative sperimentali—come perovskiti esotiche, cristalli molecolari e altri ossidi ad alto κ—questi film combinano spessore efficace molto piccolo, bassa perdita e forte comportamento alla rottura in modo che i materiali precedenti hanno faticato a uguagliare.
Avvicinare i transistor e i circuiti 2D alla realtà
Per dimostrare che il nuovo dielettrico non è solo una curiosità di laboratorio, gli autori lo integrano con disolfuro di molibdeno (MoS2) monostrato, un semiconduttore 2D ampiamente studiato come possibile successore del silicio. Costruiscono due tipi di dispositivi: transistor gate‑first, in cui il dielettrico è cresciuto prima dell’aggiunta del MoS2, e transistor gate‑last, in cui viene depositato sopra un layer di MoS2 esistente usando un sottile strato “seed” di ossido di antimonio. In entrambi i casi i dispositivi commutano in modo netto, con rapporti on/off intorno a cento milioni a uno e pendenze di soglia quasi ideali vicine al limite termico teorico. Transistor MoS2 a canale corto di soli 100 nanometri forniscono densità di corrente nello stato acceso fino a 260 microampere per micrometro a tensioni modeste, mentre la perdita attraverso il gate rimane estremamente bassa. 
Da singoli dispositivi a circuiti su wafer intero
Un test cruciale per qualsiasi nuovo approccio materiale è se può essere scalato ai grandi wafer usati nell’industria. Qui, i ricercatori crescono il loro strato di HfO2 da 1,3 nanometri in modo uniforme su un wafer di silicio da 8 pollici a soli 200 °C, una temperatura compatibile con la fabbricazione standard di chip e con materiali 2D delicati. Su questo vengono poi fabbricati circuiti logici MoS2 su scala wafer, inclusi invertitori, porte logiche di base come AND, NAND e NOR, e oscillatori ad anello a cinque stadi. Questi circuiti funzionano correttamente a tensioni di alimentazione insolitamente basse fino a 0,1–0,2 volt, mostrano elevato guadagno e consumano pochissima potenza statica, illustrando come dielettrici ultrassottili e di alta qualità si traducano direttamente in calcolo a bassa energia.
Cosa significa questo per l’elettronica di tutti i giorni
Per i non specialisti, il punto essenziale è che gli autori hanno realizzato uno dei più sottili isolanti elettrici pratici mai usati in un transistor, e sono in grado di produrlo su wafer di dimensioni industriali con metodi compatibili con l’industria. Controllando con precisione la corrente con solo poche cellule atomiche di materiale, questi film di HfO2 aiutano i transistor 2D a base di MoS2 a commutare più velocemente e a sprecare molto meno energia. Se tali tecnologie potranno essere ulteriormente affinate e integrate nei processi commerciali, potrebbero prolungare la tendenza verso dispositivi più piccoli e più efficienti, portando chip futuri sia più potenti sia più parsimoniosi dal punto di vista energetico per applicazioni che vanno dai dispositivi mobili all’hardware AI su larga scala.
Citazione: Zhang, S., Zhang, T., Yu, H. et al. Wafer-scale high-κ HfO2 dielectric films with sub-5-Å equivalent oxide thickness for 2D MoS2 transistors. Nat Commun 17, 1888 (2026). https://doi.org/10.1038/s41467-026-68584-0
Parole chiave: dielettrici ad alto-k, ossido di afnio, transistor 2D MoS2, isolanti di gate ultrassottili, elettronica a basso consumo