Clear Sky Science · it
Interferometria a scansione di coerenza ptychografica di Fourier per la morfologia 3D di micro-trincee ad alto rapporto d’aspetto e composite
Scrutare piccole trincee profonde
I moderni microchip e sensori sono costellati di scanalature ultrastrette e ultraprofonde—trincee microscopiche che possono raggiungere i 300 micrometri di profondità pur essendo larghe solo circa 10 micrometri. La loro forma tridimensionale precisa influisce in modo determinante sulle prestazioni di dispositivi come sensori di pressione, LED avanzati e meta-ottiche. Finora, osservare chiaramente queste geometrie nascoste significava o distruggere il campione o accettare misure sfocate e incomplete. Questo articolo presenta un nuovo metodo ottico che guarda attraverso il materiale invece di riflettere la luce dalla sua superficie, rivelando mappe 3D nitide di questi elementi profondi senza sezionare nulla.
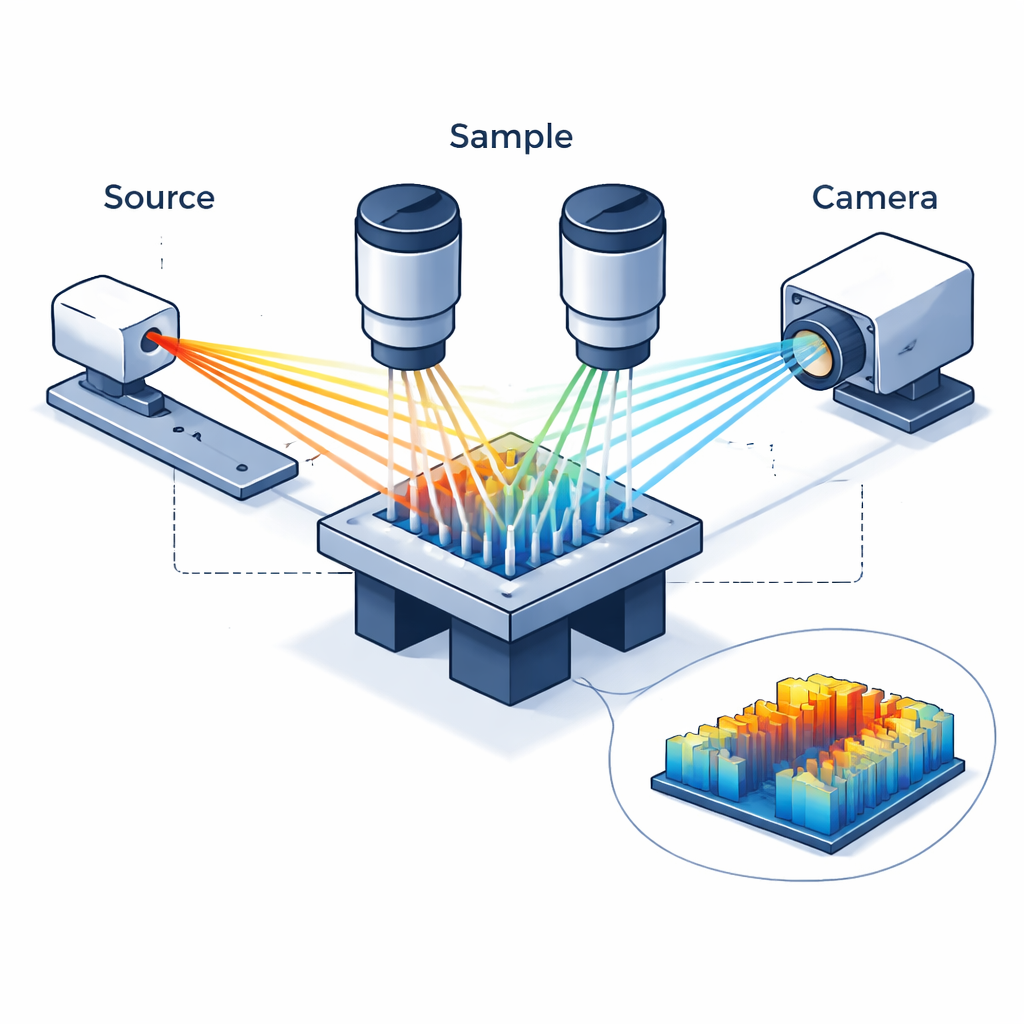
Perché le trincee profonde sono importanti
Queste trincee ad alto rapporto d’aspetto—molto profonde rispetto alla larghezza—sono elementi fondamentali della tecnologia miniaturizzata. Nei minuscoli dispositivi chiamati MEMS, servono a creare molle flessibili e strutture a pettine per misurare pressione o movimento. In LED avanzati e componenti ottici guidano la luce e aumentano l’efficienza. Tuttavia, le loro prestazioni dipendono in modo sensibile da dettagli come la planarità del fondo, la rettilineità delle pareti laterali e la corrispondenza di profondità e larghezza al progetto entro una frazione di micrometro. L’industria spesso si affida ai microscopi elettronici per questi controlli, ma questi richiedono il taglio o altri trattamenti che danneggiano il campione, rendendoli impraticabili per ispezioni di routine in linea di produzione.
Limiti degli strumenti ottici attuali
I metodi ottici non distruttivi cercano di risolvere il problema usando la luce anziché il taglio, ma hanno faticato con queste geometrie estreme. Una tecnica consolidata, l’interferometria a scansione di coerenza, illumina la superficie con luce a banda larga e analizza le frange d’interferenza per ricavare una mappa di altezza. Per strutture basse e aperte questo funziona bene. Ma in trincee profonde e strette la luce si riflette e si diffonde ripetutamente tra pareti ripide. Il risultato sono frange attenuate e segnali rumorosi, specialmente sul fondo della trincea, proprio dove gli ingegneri hanno bisogno di misure affidabili. Usare una illuminazione più debole e a bassa angolazione può migliorare la chiarezza del segnale, ma a scapito dei dettagli fini, imponendo un compromesso tra risoluzione e affidabilità.
Guardare attraverso invece che soltanto verso
L’approccio degli autori, chiamato interferometria a scansione di coerenza ptychografica di Fourier (FP-CSI), modifica la geometria della misura. Invece di riflettere la luce dal campione, il sistema invia luce nel vicino infrarosso attraverso una fetta di silicio trasparente in un interferometro bilanciato con cura. Un piccolo punto di illuminazione viene spostato lateralmente in modo che il campione sia esaminato da molti angoli leggermente diversi di luce quasi parallela. Poiché la luce attraversa la struttura una sola volta e con bassa divergenza, il segnale è molto meno distorto e le frange d’interferenza rimangono forti anche sul fondo di trincee molto profonde. Il metodo corregge quindi sottili distorsioni nei segnali registrati e combina le molte viste angolate nel dominio delle frequenze, fondendo di fatto un’apertura ottica più ampia e recuperando dettagli fini senza calcoli iterativi pesanti.
Mappe 3D nitide di dispositivi reali
Usando FP-CSI, il team ha misurato singole trincee in silicio profonde 300 micrometri con larghezze fino a 10 micrometri, oltre a sensori di pressione MEMS multilivello complessi contenenti più livelli di trincee. In tutti i casi, il metodo ha prodotto mappe tridimensionali dettagliate che corrispondevano strettamente alle misure di controllo effettuate con microscopi elettronici, senza alcun danneggiamento del campione. Gli errori di larghezza e profondità erano dell’ordine dell’uno percento o meno su prove ripetute. Il sistema è stato in grado di risolvere elementi lineari distanti solo 1,3 micrometri—praticamente al limite fondamentale di risoluzione imposto dall’ottica—e, cosa cruciale, ha mantenuto quasi questo livello di nitidezza sul fondo di trincee modello con rapporti d’aspetto superiori a 10:1, dove gli interferometri riflettenti standard fallivano in gran parte.

Cosa significa per la produzione futura
Per i non specialisti, il messaggio chiave è che FP-CSI offre un modo per “vedere” la forma 3D esatta di scanalature estremamente profonde e strette all’interno di microdispositivi trasparenti in modo rapido e senza aprirli. Combinando i punti di forza di due idee di imaging precedentemente separate—la misura di altezza basata sull’interferenza e l’imaging sintetico multi-angolo—la tecnica supera un compromesso di lunga data tra chiarezza e affidabilità. Questo la rende uno strumento promettente per la prossima generazione di fabbricazione di semiconduttori, produzione MEMS e altri sistemi micro-optoelettronici in cui forme microscopiche invisibili determinano se un dispositivo supera i controlli o fallisce.
Citazione: Li, Y., Yuan, Q., Huo, X. et al. Fourier ptychographic coherence scanning interferometry for 3D morphology of high aspect ratio and composite micro-trenches. Light Sci Appl 15, 93 (2026). https://doi.org/10.1038/s41377-026-02189-6
Parole chiave: metrologia ottica 3D, micro-trincee, ispezione MEMS, interferometria, produzione di semiconduttori