Clear Sky Science · he
סרטי דיאלקטרי HfO2 בעלים גבוהים בקנה מידה של וופרים עם עובי חמצן שקול מתחת ל-5 Å עבור טרנזיסטורים 2D של MoS2
מדוע מבודדים דקים חשובים עבור השבבים של העתיד
טלפונים חכמים, מרכזי נתונים ובינה מלאכותית מסתמכים על מפסקים אלקטרוניים זעירים הקרויים טרנזיסטורים. כדי להמשיך לצופף יותר מפסקים אלה בתוך שבבים תוך הקטנת צריכת האנרגיה, מהנדסים חייבים להקטין לא רק את הטרנזיסטורים עצמם אלא גם את שכבות הבידוד שמנהלות את התנהגותם. מאמר זה מתאר שיטה לייצור סרט בידוד דק מאוד ובאיכות גבוהה שעדיין חוסם דליפת זרם חשמלי, ושימוש בו על פני וופרים בגודל מלא במעגלי טרנזיסטורים דו־ממדיים (2D) מתקדמים.
סוג חדש של מחסום חשמלי אולטרה־דק
במרכזו של כל טרנזיסטור מודרני נמצא "שער" שמדליק וכיבה את הזרם בערוץ. ביניהם נמצאת שכבת בידוד דקה, או דיאלקטריק. במשך שנים התעשייה השתמשה בחמצן ההפניום (HfO2), חומר בעל מקדם דיאלקטרי גבוה שמאפשר שליטה חזקה על הערוץ בלי צורך בעובי פיזי גדול. אך דחיפת גישה זו אל תחום של כמה שכבות אטומיות היתה קשה: סרטים נוטים לדלוף יותר מדי זרם או להיקרע תחת עומס חשמלי. המחברים מציגים שיטת צמיחה משופרת, המכונה שיכוב שכבות אטומיות עם חמצון כפול (MOALD), שמייצרת סרטי HfO2 בעובי של רק 1.3 ננומטר — רק כמה אטומים — תוך שמירה על צפיפות נמוכה של מגרעות ואיכות גבוהה דיו לתפקוד אמין. 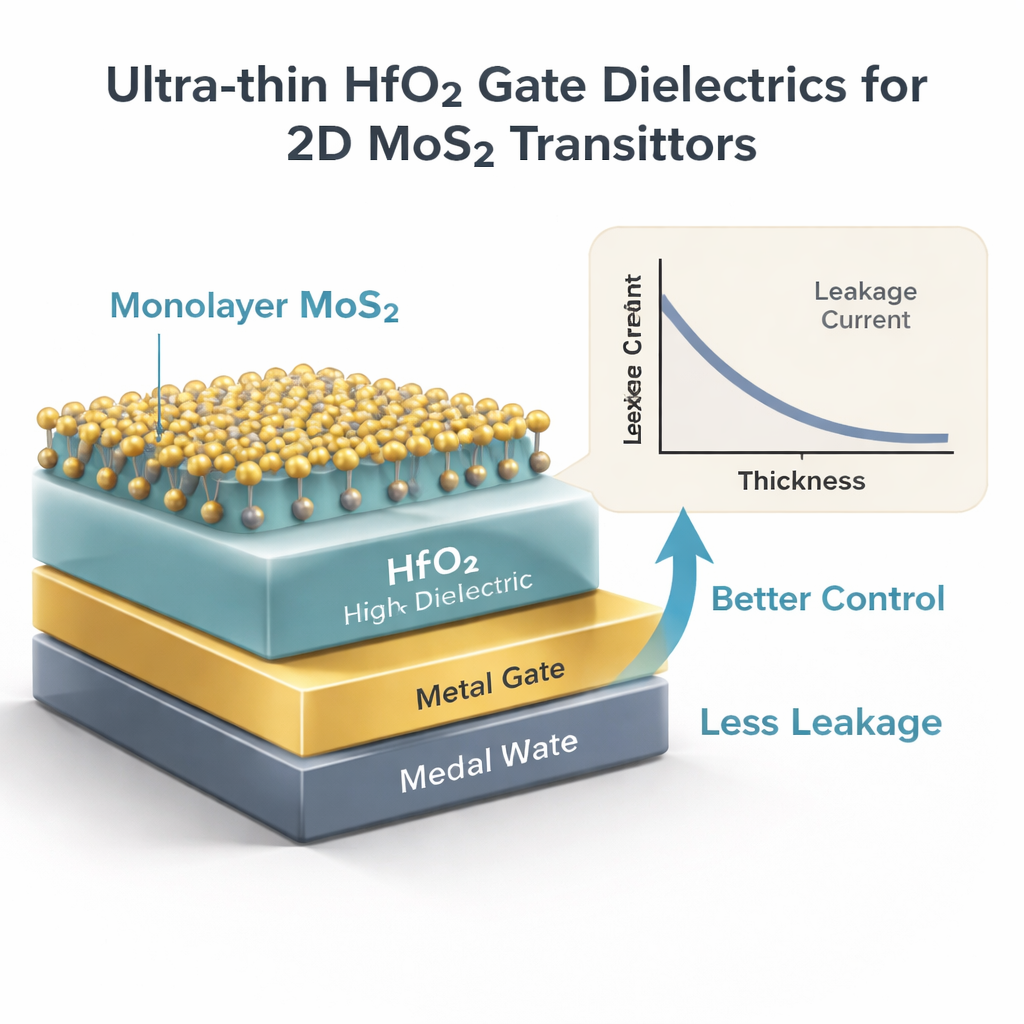
ניקוי פגמים בקנה מידה אטומי
צמיחה מקובלת של HfO2 במעבדה נוטה להשתמש בצעד חמצון יחיד, שמותיר אחריו מגרעי־חמצן רבים. אלו מתפקדים כקיצורי דרך לאלקטרונים ומחלישים את יכולת הבידוד. בגישת MOALD, כל מחזור צמיחה כולל שתי פעימות חמצון — תחילה בעזרת אוזון ולאחר מכן בפלזמת חמצן. מיקרוסקופיה וספקטרוסקופיה מראות כי הטיפול המשולב מצמצם בחדות את הוואקנציות של חמצן, ומניב סרטים חלקים ורציפים אפילו בעובי של 1.3 ננומטר. סימולציות מחשב תומכות בכך: כאשר הפגמים רבים, הפסיון האלקטרוני של החומר מצטמצם ומופיעים מצבים נוספים בתוך הפסיון, מה שמקל על קריעת המשטח. כאשר המגרעים ממוזערים, הפסיון מתרחב ודרכי הדליפה מדוכאות, מה שמחזיר את עוצמת הדיאלקטריק.
בידוד שיא־דק עם דליפה נמוכה
הצוות מודד את הסרטים האולטרה־דקים במבני מבחן פשוטים מתכת–דיאלקטריק–מתכת. למרות העובי הפיזי הזעיר שלהם, שכבות HfO2 מתנהגות כמו שכבה דקה בהרבה של חמצן־הסיליקון המסורתי מבחינת השליטה החשמלית, והושג עובי חמצן שקול של רק 2.5 א̊נגסטרום. זה מתחת ליעדים האגרסיביים שנקבעו במפות דרכים בינלאומיות למכשירי לוגיקה עתידיים. באופן מכריע, זרמי דליפה נשארים מתחת למיקרואמפרו אחד למשך סנטימטר מרובע במתחי פעולה, והסרטים עומדים בשדות חשמליים מעל 22 מגה־וולט לסנטימטר בטרם קריעה. בהשוואה למגוון רב של אלטרנטיבות ניסיוניות — כגון פרובסקיטים אקזוטיים, גבישים מולקולריים וחמצנים בעלי k גבוה אחרים — סרטים אלה משלבים עובי יעיל מאוד קטן, דליפה נמוכה והתנהגות קריעה חזקה באופן שקודם לכן חומרים אחרים התקשו לשלב.
להביא את הטרנזיסטורים ומעגלי ה‑2D קרובים יותר למציאות
כדי להראות שהדיאלקטריק החדש אינו סתם סקרנות מעבדתית, המחברים משלבים אותו עם מונושכבת של דיסולפיד המוליבדן (MoS2), מוליך למחצה 2D שנחקר נרחב כתחליף אפשרי לסיליקון. הם בונים שני סוגי מכשירים: טרנזיסטורים בסדר שער־קודם, שבהם הדיאלקטריק נבנה לפני הוספת ה‑MoS2, וטרנזיסטורים בסדר שער־אחרון, שבהם הוא נשפך על שכבת MoS2 קיימת באמצעות שכבת "גרעין" דקה של חמצן אנטימוני. בשני המקרים המכשירים מתחלפים בניקיון, עם יחס on/off סביב מאה מיליון לאחד ושיפועים תת‑סף כמעט אידאיים, קרובים לגבול התרמי התיאורטי. טרנזיסטורים קצרי‑ערוץ של MoS2 באורך של 100 ננומטר מספקים צפיפי זרם במצב on עד 260 מיקרואמפר לאמפר למיקרומטר במתחים מתונים, בעוד דליפת שער נותרת נמוכה מאוד. 
ממכשירים יחידים למעגלים על וופר מלא
מבחן מרכזי לכל גישה חומרית חדשה הוא האם ניתן להקצבה לוופרים הגדולים בהם משתמשת התעשייה. כאן, החוקרים מגדלים את שכבת ה‑HfO2 בעובי 1.3 ננומטר באופן אחיד על וופר סיליקון בגודל 8 אינץ' בטמפרטורה של רק 200 °C, טמפרטורה התואמת לייצור שבבים סטנדרטי ולחומרים 2D רגישים. מעליה הם מייצרים מעגלי לוגיקה של MoS2 בקנה מידה של וופר, כולל מהפכים, שערי לוגיקה בסיסיים כמו AND, NAND ו‑NOR, ומחוללי תנודה טבעתיים חמישה שלבים. מעגלים אלה פועלים נכון במתחי אספקה נמוכים באופן חריג עד 0.1–0.2 וולט, מראים הגבר גבוה וצריכת הספק סטטי מינימלית, ומדגימים כיצד דיאלקטרים דקיקים ואיכותיים מאוד מתורגמים ישירות לחישוב צריכת‑אנרגיה נמוכה.
מתי זה משמעותי לאלקטרוניקה היומיומית
עבור לא‑מומחים, המסר הוא שהמחברים בנו אחד מחומרי הבידוד הפרקטיים הדקים ביותר ששימשו אי‑פעם בטרנזיסטור, והם יכולים לייצרו על וופרים בגודל מלא באמצעות שיטות ידידותיות לתעשייה. על ידי שליטה הדוקה בזרם עם רק כמה שכבות אטומיות של חומר, סרטי HfO2 אלה מסייעים לטרנזיסטורים 2D של MoS2 להתחלף מהר יותר ולבזבז הרבה פחות אנרגיה. אם טכנולוגיות כאלה יעברו שיפור נוסף וישולבו בתהליכים מסחריים, הן יכולות להאריך את מגמת ההקטנה והשיפור ביעילות האלקטרוניקה, ולהביא שבבים עתידיים שיותר חזקים וחסכוניים באנרגיה עבור יישומים מטלפונים ניידים ועד חומרה רחבת‑היקף של בינה מלאכותית.
ציטוט: Zhang, S., Zhang, T., Yu, H. et al. Wafer-scale high-κ HfO2 dielectric films with sub-5-Å equivalent oxide thickness for 2D MoS2 transistors. Nat Commun 17, 1888 (2026). https://doi.org/10.1038/s41467-026-68584-0
מילות מפתח: דיאלקטרים בעלי k גבוה, חמצן ההפניום, טרנזיסטורים 2D של MoS2, מבודדים לשער דקיקים מאוד, אלקטרוניקה צריכת־אנרגיה נמוכה