Clear Sky Science · fr
Interférométrie de balayage de cohérence ptychographique de Fourier pour la morphologie 3D de micro-tranchées composites et à grand rapport d’aspect
Regarder à l’intérieur de minuscules tranchées profondes
Les microprocesseurs et capteurs modernes sont sillonnés de rainures ultra-étroites et très profondes — des tranchées microscopiques pouvant atteindre 300 micromètres de profondeur pour seulement environ 10 micromètres de large. Leur forme tridimensionnelle exacte influence fortement les performances d’appareils tels que les capteurs de pression, les LED avancées et les métas-optiques. Jusqu’à présent, visualiser clairement ces formes cachées impliquait soit d’endommager l’échantillon, soit d’accepter des mesures floues et incomplètes. Cet article présente une nouvelle méthode optique qui regarde à travers le matériau au lieu de se contenter de réfléchir la lumière à sa surface, révélant des cartes 3D nettes de ces structures profondes sans rien découper.
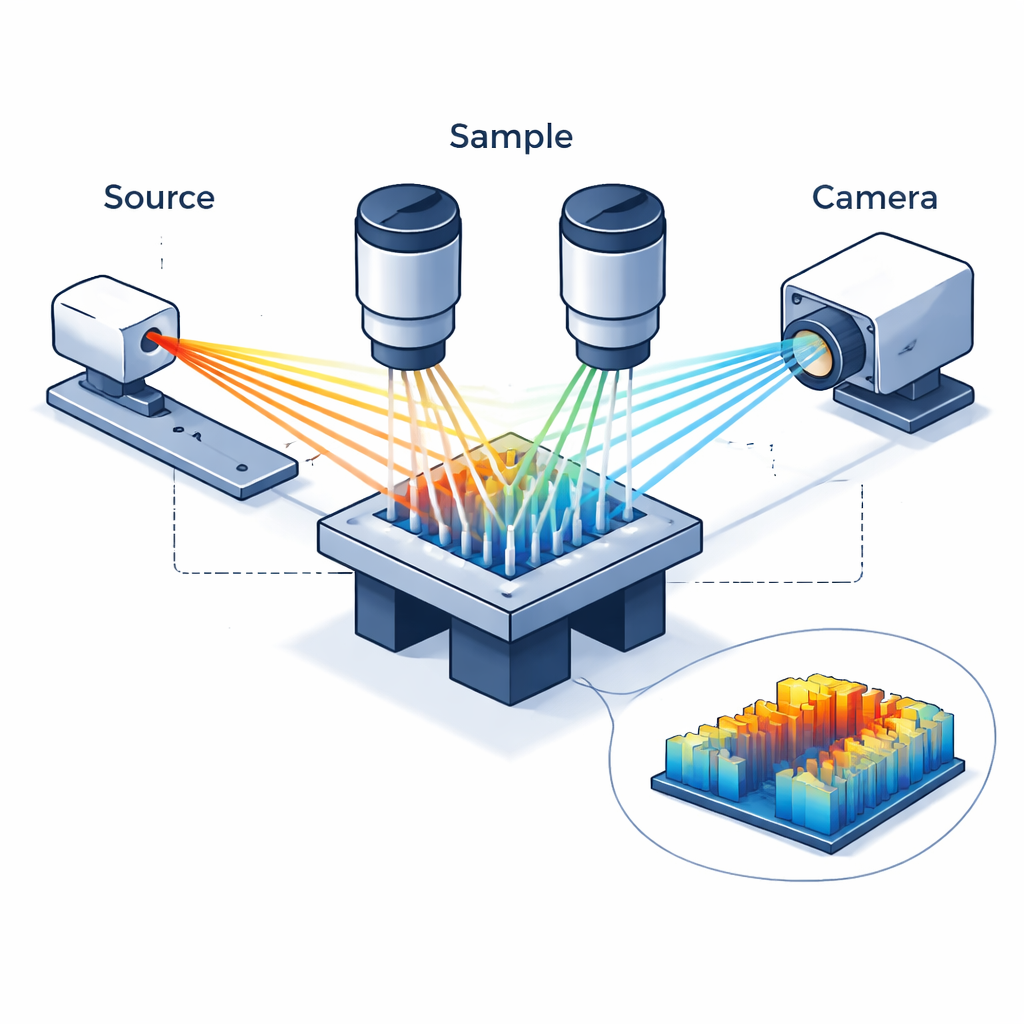
Pourquoi les tranchées profondes comptent
Ces tranchées à grand rapport d’aspect — très profondes comparées à leur largeur — sont des éléments clés de la technologie miniaturisée. Dans de minuscules machines appelées MEMS, elles forment des ressorts flexibles et des structures en peigne pour mesurer la pression ou le mouvement. Dans les LED avancées et composants optiques, elles guident la lumière et augmentent l’efficacité. Cependant, leurs performances dépendent de détails tels que la planéité du fond, la rectitude des parois latérales, et la conformité de la profondeur et de la largeur au design avec une précision de l’ordre de la fraction de micromètre. L’industrie s’appuie souvent sur des microscopes électroniques pour ces vérifications, mais ceux-ci nécessitent de couper ou d’endommager l’échantillon, ce qui est impraticable pour l’inspection de routine en ligne.
Limites des outils optiques actuels
Les méthodes optiques non destructives tentent de résoudre ce problème en utilisant la lumière plutôt que la découpe, mais elles peinent face à ces géométries extrêmes. Une technique répandue, l’interférométrie de balayage de cohérence, éclaire la surface avec une lumière à large bande et analyse les franges d’interférence pour reconstruire une carte de hauteur. Pour des structures peu profondes et ouvertes, cela fonctionne bien. Mais dans des tranchées profondes et étroites, la lumière se réfléchit et se diffuse plusieurs fois entre des parois abruptes. Le résultat est des franges atténuées et des signaux bruités, en particulier au fond de la tranchée, précisément là où les ingénieurs ont besoin de mesures fiables. L’utilisation d’une illumination atténuée et à faible angle peut améliorer la clarté du signal, mais au prix d’un flou des détails fins, imposant un compromis entre résolution et fiabilité.
Regarder à travers plutôt que seulement sur
L’approche des auteurs, appelée interférométrie de balayage de cohérence ptychographique de Fourier (FP-CSI), change la géométrie de mesure. Au lieu de réfléchir la lumière sur l’échantillon, le système envoie de la lumière proche infrarouge à travers une plaquette de silicium transparente dans un interféromètre soigneusement équilibré. Un minuscule point d’illumination est décalé latéralement de sorte que l’échantillon soit sondé par de nombreux angles légèrement différents d’une lumière presque parallèle. Parce que la lumière traverse la structure une seule fois et avec une faible divergence, le signal est beaucoup moins déformé, et les franges d’interférence restent fortes même au fond de tranchées très profondes. La méthode corrige ensuite les distorsions subtiles des signaux enregistrés et combine les nombreuses vues sous différents angles dans le domaine fréquentiel, assemblant de fait une ouverture optique synthétique plus grande et récupérant des détails fins sans calculs itératifs lourds.
Cartes 3D nettes d’appareils réels
Avec la FP-CSI, l’équipe a mesuré des tranchées simples en silicium de 300 micromètres de profondeur et de largeurs aussi petites que 10 micromètres, ainsi que des capteurs de pression MEMS multicouches plus complexes contenant plusieurs niveaux de tranchées. Dans tous les cas, la méthode a produit des cartes tridimensionnelles détaillées qui correspondaient étroitement aux mesures de référence réalisées par microscopie électronique, mais sans aucun endommagement de l’échantillon. Les erreurs de largeur et de profondeur étaient de l’ordre d’un pourcent ou moins sur des essais répétés. Le système a pu résoudre des traits distants de seulement 1,3 micromètre — essentiellement à la limite fondamentale de résolution imposée par l’optique — et, surtout, a maintenu presque ce niveau de netteté au fond de tranchées modèles avec des rapports d’aspect supérieurs à 10:1, où les interféromètres réfléchissants standard échouaient en grande partie.

Ce que cela signifie pour la fabrication de demain
Pour les non-spécialistes, le message-clé est que la FP-CSI offre un moyen de « voir » la forme 3D exacte de rainures extrêmement profondes et étroites à l’intérieur de microdispositifs transparents, rapidement et sans les ouvrir. En combinant les forces de deux idées d’imagerie auparavant séparées — la mesure de hauteur par interférence et l’imagerie synthétique multi-angle — la technique surmonte un compromis de longue date entre clarté et fiabilité. Cela en fait un outil prometteur pour la fabrication de semi-conducteurs de nouvelle génération, la production de MEMS et d’autres systèmes micro-optoélectroniques où des formes minuscules invisibles déterminent si un dispositif est conforme ou non.
Citation: Li, Y., Yuan, Q., Huo, X. et al. Fourier ptychographic coherence scanning interferometry for 3D morphology of high aspect ratio and composite micro-trenches. Light Sci Appl 15, 93 (2026). https://doi.org/10.1038/s41377-026-02189-6
Mots-clés: métrologie optique 3D, micro-tranchées, inspection MEMS, interférométrie, fabrication de semi-conducteurs