Clear Sky Science · es
Interferometría de escaneo de coherencia ptychográfica de Fourier para la morfología 3D de micro-zanjas de alta relación de aspecto y compuestas
Asomarse a minúsculas y profundas zanjas
Los microchips y sensores modernos están llenos de ranuras ultrafinas y muy profundas: zanjas microscópicas que pueden alcanzar 300 micrómetros de profundidad y apenas unos 10 micrómetros de ancho. Su forma tridimensional exacta influye de manera determinante en el rendimiento de dispositivos como sensores de presión, LEDs avanzados y meta-óptica. Hasta ahora, obtener una visión nítida de estas geometrías ocultas implicaba o bien dañar la muestra o conformarse con mediciones borrosas e incompletas. Este artículo presenta un nuevo método óptico que mira a través del material en lugar de solo reflejar la luz en su superficie, revelando mapas 3D nítidos de estas características profundas sin cortar nada.
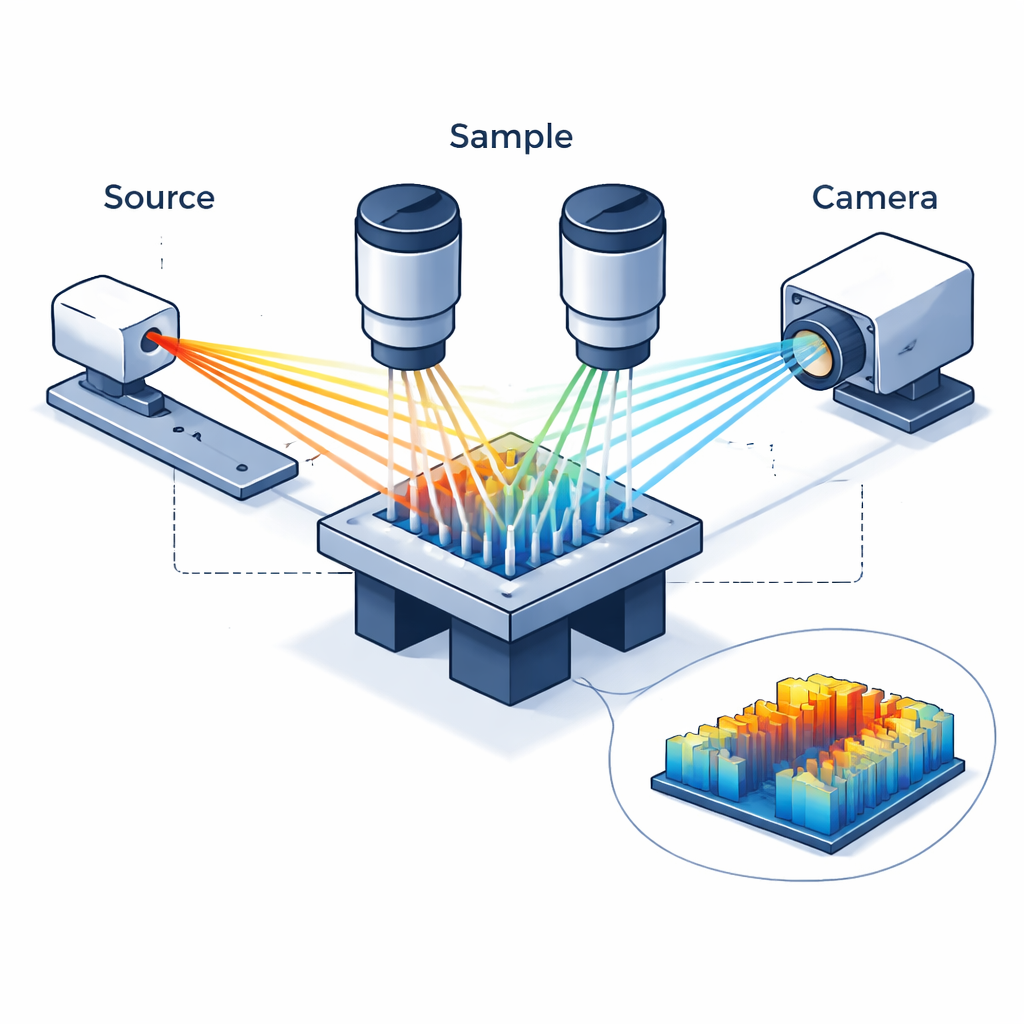
Por qué importan las zanjas profundas
Estas zanjas de alta relación de aspecto —muy profundas en comparación con su ancho— son elementos fundamentales de la tecnología miniaturizada. En pequeñas máquinas llamadas MEMS, forman resortes flexibles y estructuras en peine para medir presión o movimiento. En LEDs avanzados y componentes ópticos, guían la luz y aumentan la eficiencia. Sin embargo, su desempeño depende de detalles como la suavidad del fondo, la rectitud de las paredes laterales y que la profundidad y el ancho cumplan el diseño con una fracción de micrómetro de precisión. La industria suele recurrir al microscopio electrónico para estas comprobaciones, pero eso requiere seccionar o dañar la muestra, lo cual es inviable para inspecciones rutinarias en línea.
Límites de las herramientas ópticas actuales
Los métodos ópticos no destructivos intentan resolver esto utilizando luz en lugar de cortar, pero han tenido dificultades con estas geometrías extremas. Una técnica destacada, la interferometría de escaneo de coherencia, ilumina la superficie con luz de banda ancha y analiza las franjas de interferencia para construir un mapa de alturas. Para estructuras poco profundas y abiertas esto funciona bien. Pero en zanjas profundas y estrechas, la luz se refleja y dispersa múltiples veces entre paredes pronunciadas. El resultado son franjas apagadas y señales ruidosas, especialmente en el fondo de la zanja, precisamente donde los ingenieros necesitan mediciones fiables. Emplear una iluminación más débil y de ángulo bajo puede mejorar la claridad de la señal, pero a costa de difuminar detalles finos, obligando a un compromiso entre resolución y fiabilidad.
Mirar a través en vez de solo hacia
El enfoque de los autores, llamado interferometría de escaneo de coherencia ptychográfica de Fourier (FP-CSI), cambia la geometría de la medición. En lugar de reflejar la luz en la muestra, el sistema envía luz infrarroja cercana a través de una oblea de silicio transparente dentro de un interferómetro equilibrado con precisión. Un diminuto punto de iluminación se desplaza lateralmente para que la muestra sea sondeada por muchos ángulos ligeramente distintos de luz casi paralela. Dado que la luz atraviesa la estructura una sola vez y con baja divergencia, la señal se distorsiona mucho menos y las franjas de interferencia se mantienen fuertes incluso en el fondo de zanjas muy profundas. El método corrige después distorsiones sutiles en las señales registradas y combina las múltiples vistas anguladas en el dominio de la frecuencia, cosiendo eficazmente una apertura óptica mayor y recuperando detalles finos sin cálculos iterativos pesados.
Mapas 3D nítidos de dispositivos reales
Con FP-CSI, el equipo midió zanjas de silicio individuales de 300 micrómetros de profundidad con anchos de hasta 10 micrómetros, así como sensores de presión MEMS multicapa complejos que contienen varios niveles de zanjas. En todos los casos, el método produjo mapas tridimensionales detallados que coincidieron estrechamente con mediciones de control por microscopía electrónica, pero sin dañar las muestras. Los errores en ancho y profundidad estuvieron en torno al uno por ciento o menos en pruebas repetidas. El sistema resolvió características lineales separadas por apenas 1,3 micrómetros —prácticamente en el límite de resolución impuesto por la óptica— y, lo que es crucial, mantuvo casi ese nivel de nitidez en el fondo de zanjas modelo con relaciones de aspecto superiores a 10:1, donde los interferómetros reflectivos estándar fallaban en gran medida.

Qué significa esto para la fabricación futura
Para los no especialistas, el mensaje clave es que FP-CSI ofrece una forma de “ver” la forma 3D exacta de ranuras extremadamente profundas y estrechas dentro de microdispositivos transparentes de manera rápida y sin abrirlos. Al combinar las fortalezas de dos ideas de imagen que antes estaban separadas —la medición de altura basada en interferencia y la imagen sintética multiángulo— la técnica supera un compromiso de larga data entre claridad y fiabilidad. Esto la convierte en una herramienta prometedora para la siguiente generación de fabricación de semiconductores, producción de MEMS y otros sistemas micro-optoelectrónicos en los que formas diminutas invisibles determinan si un dispositivo aprueba o no.»
Cita: Li, Y., Yuan, Q., Huo, X. et al. Fourier ptychographic coherence scanning interferometry for 3D morphology of high aspect ratio and composite micro-trenches. Light Sci Appl 15, 93 (2026). https://doi.org/10.1038/s41377-026-02189-6
Palabras clave: Metrología óptica 3D, micro-zanjas, inspección MEMS, interferometría, fabricación de semiconductores