Clear Sky Science · de
Fourier-ptychographische Kohärenz-Scan-Interferometrie zur 3D-Morphologie von Mikrogräben mit großem Aspektverhältnis und Verbundstrukturen
Blick in winzige, tiefe Gräben
Moderne Mikrochips und Sensoren enthalten ultraschmale, ultratiefe Rillen — mikroskopische Gräben, die bis zu 300 Mikrometer tief, aber nur etwa 10 Mikrometer breit sein können. Ihre genaue dreidimensionale Form beeinflusst maßgeblich die Leistung von Bauteilen wie Drucksensoren, fortschrittlichen LEDs und Metaoptiken. Bislang bedeutete das klare Erkennen dieser verborgenen Formen entweder die Beschädigung der Probe oder die Akzeptanz verschwommener, unvollständiger Messungen. Diese Arbeit stellt eine neue optische Methode vor, die durch das Material hindurch statt nur davon zurückreflektierend blickt und so gestochen scharfe 3D-Karten dieser tiefen Strukturen liefert, ohne etwas aufzuschneiden.
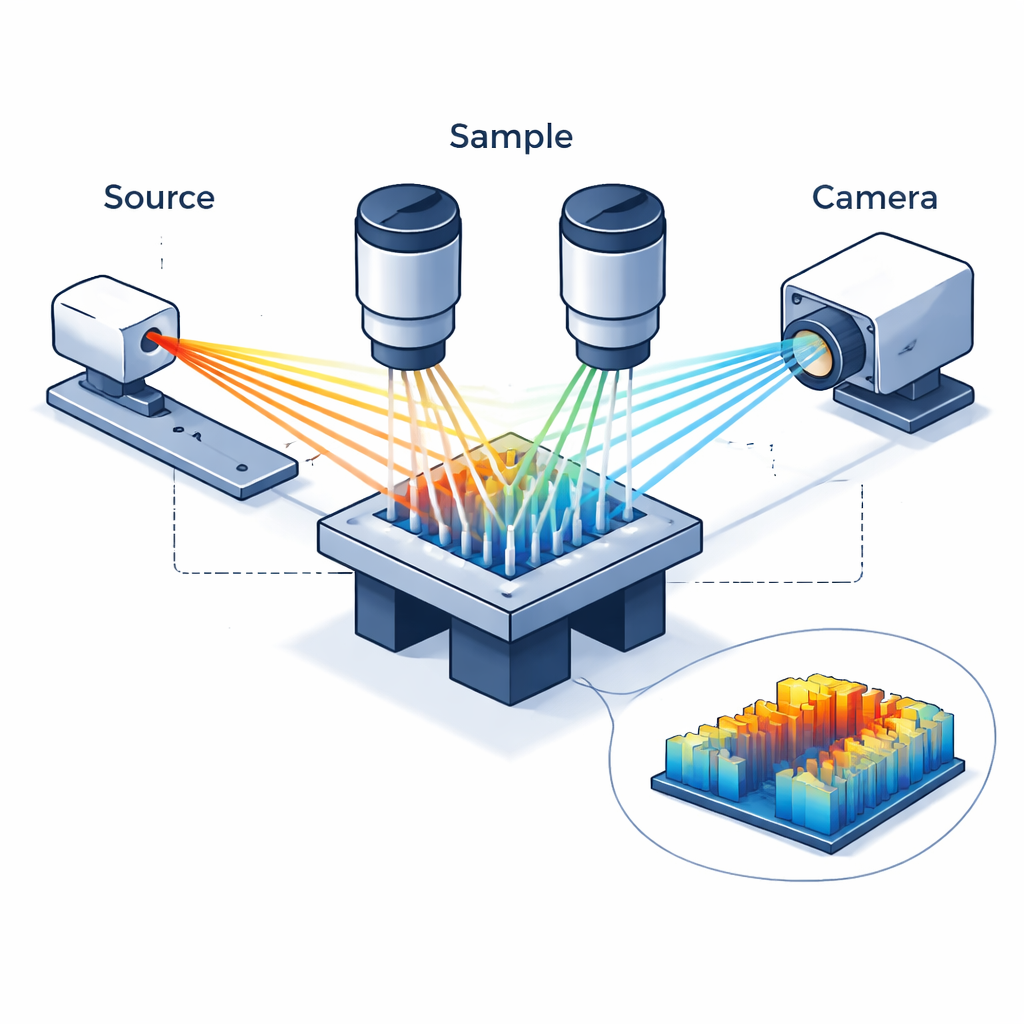
Warum tiefe Gräben wichtig sind
Diese Gräben mit hohem Aspektverhältnis — sehr tief im Verhältnis zu ihrer Breite — sind Arbeitspferde der Miniaturtechnik. In winzigen Maschinen, den MEMS, bilden sie flexible Federn und kammartige Strukturen zur Messung von Druck oder Bewegung. In fortschrittlichen LEDs und optischen Bauteilen lenken sie Licht und steigern die Effizienz. Ihre Funktion hängt jedoch empfindlich von Details ab, etwa wie glatt der Boden ist, wie gerade die Seitenwände verlaufen und ob Tiefe und Breite innerhalb eines Bruchteils eines Mikrometers dem Design entsprechen. Die Industrie verlässt sich oft auf Elektronenmikroskope für solche Prüfungen, doch diese erfordern das Aufschneiden oder anderweitige Beschädigen der Probe, was für routinemäßige Inline-Inspektionen unpraktisch ist.
Grenzen heutiger optischer Werkzeuge
Nicht-destruktive optische Verfahren versuchen, dieses Problem durch den Einsatz von Licht statt Schneiden zu lösen, haben aber bei solchen extremen Geometrien Schwierigkeiten. Ein führendes Verfahren, die Kohärenz-Scan-Interferometrie, beleuchtet eine Oberfläche mit Breitbandlicht und analysiert Interferenzstreifen, um eine Höhenkarte zu erzeugen. Für flache, offene Strukturen funktioniert das gut. In tiefen und engen Gräben aber reflektiert und streut Licht mehrfach zwischen steilen Wänden. Das Ergebnis sind ausgelöschte Streifen und verrauschte Signale, besonders am Grabenboden — genau dort, wo verlässliche Messungen erforderlich sind. Schwächere, flachere Beleuchtung kann die Signalqualität verbessern, führt jedoch zu einer Verwischung feiner Details und erzwingt einen Kompromiss zwischen Auflösung und Zuverlässigkeit.
Durchschauen statt nur anblicken
Der Ansatz der Autoren, genannt Fourier-ptychographische Kohärenz-Scan-Interferometrie (FP-CSI), ändert die Geometrie der Messung. Statt Licht von der Probe zurückreflektieren zu lassen, sendet das System nahes Infrarotlicht durch eine transparente Siliziumscheibe in einem sorgfältig ausbalancierten Interferometer. Ein winziger Beleuchtungsfleck wird seitlich verschoben, sodass die Probe mit vielen leicht unterschiedlichen Winkeln nahezu parallelen Lichts sondiert wird. Da das Licht die Struktur nur einmal und mit geringer Divergenz durchläuft, wird das Signal deutlich weniger verzerrt, und die Interferenzstreifen bleiben selbst am Boden sehr tiefer Gräben stark. Die Methode korrigiert dann subtile Verzerrungen in den aufgezeichneten Signalen und kombiniert die vielen Blickwinkel im Frequenzbereich, wodurch sich effektiv eine größere optische Apertur zusammensetzt und feine Details ohne aufwendige, iterative Rechnungen zurückgewonnen werden.
Scharfe 3D-Karten realer Bauteile
Mit FP-CSI vermessete das Team einzelne Siliziumgräben von 300 Mikrometern Tiefe mit Breiten bis zu 10 Mikrometern sowie komplexe mehrschichtige MEMS-Drucksensoren mit mehreren Grabenebenen. In allen Fällen lieferte die Methode detaillierte dreidimensionale Karten, die gut mit Kontrollmessungen mittels Elektronenmikroskopie übereinstimmten — jedoch ohne Probenbeschädigung. Breiten- und Tiefenabweichungen lagen bei wiederholten Messungen bei etwa einem Prozent oder weniger. Das System konnte Linienmerkmale mit nur 1,3 Mikrometern Abstand auflösen — faktisch am fundamentalen Auflösungsgrenzwert der Optik — und hielt diese Schärfe entscheidend auch am Boden von Modellgräben mit Aspektverhältnissen größer als 10:1, wo reflektierende Interferometer weitgehend versagten.

Was das für die Fertigung der Zukunft bedeutet
Für Nicht-Spezialisten lautet die Kernbotschaft: FP-CSI bietet eine Möglichkeit, die exakte 3D-Form extrem tiefer und schmaler Rillen in transparenten Mikrobauteilen schnell und ohne Aufschneiden sichtbar zu machen. Durch die Kombination der Stärken zweier zuvor getrennter Bildgebungsansätze — interferometrischer Höhenmessung und mehrwinkeliger synthetischer Abbildung — überwindet die Technik den langjährigen Kompromiss zwischen Klarheit und Zuverlässigkeit. Dadurch ist sie ein vielversprechendes Werkzeug für die nächste Generation der Halbleiterfertigung, MEMS-Herstellung und andere mikro-optoelektronische Systeme, in denen unsichtbare winzige Formen darüber entscheiden, ob ein Bauteil besteht oder ausfällt.
Zitation: Li, Y., Yuan, Q., Huo, X. et al. Fourier ptychographic coherence scanning interferometry for 3D morphology of high aspect ratio and composite micro-trenches. Light Sci Appl 15, 93 (2026). https://doi.org/10.1038/s41377-026-02189-6
Schlüsselwörter: 3D optische Messtechnik, Mikrogräben, MEMS-Inspektion, Interferometrie, Halbleiterfertigung